
单管和双管放大器的频响分析 R>11gm Re >11gm A 9m 11R: A 1 R dp 00 00 00 Rout 9mRBrds 1/gm 1/gm 图2-2共源放大器和源极跟随器的增益和输入、输出阻抗 Ra >11gm Ra >11gm A R R 9mrds Rg Ri 1/gm 11gm R Raut 9mrdsRB P 9mlasRg 00 图2-3共栅放大器的增益和输入、输出阻抗 2.2晶体管器件电容 2.2.1器件电容分类 为了研究电路频率响应特性,必须先对晶体管器件电容加以简单介绍,如图24所示, 晶体管器件电容可以划分为以下几类: (1)栅极和沟道之间的栅氧化层电容Cx (2)衬底与沟道之间的耗尽层电容Cc (3)由于多晶硅栅和源极、漏极相互交叠形成的交叠电容C (4)源极、漏极与衬底之间的结电容,包括与结底部相关的下极板电容Csb、Cb 和由于结周围引起的侧壁电容Cwsb、Cwdb 6
单管和双管放大器的频响分析 6 RS iOUT Rout RB vIN iOUT Rout vIN vIN IB vOUT Rout RS vIN vOUT Rout RB 图 2-2 共源放大器和源极跟随器的增益和输入、输出阻抗 Rout i RB in vOUT RL iin vOUT RL IB vOUT vOUT Rin Rout Rin Rout Rin Rout Rin i RB iin IB in 图 2-3 共栅放大器的增益和输入、输出阻抗 2.2 晶体管器件电容 2.2.1 器件电容分类 为了研究电路频率响应特性,必须先对晶体管器件电容加以简单介绍,如图 2-4 所示, 晶体管器件电容可以划分为以下几类: (1) 栅极和沟道之间的栅氧化层电容 Cox (2) 衬底与沟道之间的耗尽层电容 Cbc (3) 由于多晶硅栅和源极、漏极相互交叠形成的交叠电容 Cov (4) 源极、漏极与衬底之间的结电容,包括与结底部相关的下极板电容 Cjsb 、Cjdb 和由于结周围引起的侧壁电容 Cjwsb 、Cjwdb g r R m ds B g r R m ds B 1/gm RL RL 1/gm AR Rin Rout R g B m 1/ g r R m ds B - RB R g B m 1/ R g B m 1/ R g B m 1/ 1 m 1/gm 1/g AG gm 1/RB AV 1 Rin ds g R r m B ds r Rout

第二章单管电路低频特性以及晶体管电容 Gate Polysilicon Metal(Al) Source Drain SiO, Q a Cbc 干C和 Cjwsb p Bulk or substrate Bulk 6 gbo 图2-4()NMOS晶体管横截面(包含器件电容)(b)NMOS俯视图 Go oB Cgs gmVgs >gmbs乏Ids Vos Csh So oS 图2-5MOS晶体管高频小信号模型 2.2.2器件电容大小的详细讨论 下面我们对图2-5中MOS晶体管高频小信号模型中的各个器件电容进行比较详细 的讨论: (1)栅寄生电容Cgs和Cgd 栅寄生电容包括栅源电容Cgs和栅漏电容Cgd,在不同工作区域时,Cgs和Cgd大小 会发生变化,所以我们将根据晶体管的不同工作区域来讨论这两个电容的大小。 Go oB Csb Cgb 图2-6MOS晶体管器件电容
第二章 单管电路低频特性以及晶体管电容 7 S G D W L B Cgbo n+ n+ p– Bulk or substrate Source Drain Gate Metal(Al) Polysilicon SiO2 Bulk Cov Cox Cjsb Cjdb (a) (b) Cjwsb Cjwdb Cov Cbc 图 2-4 (a) NMOS 晶体管横截面(包含器件电容)(b) NMOS 俯视图 G S gmvgs D vgs gmvbs rds B vbs S Cgs Cgd Cdb Csb Cgb 图 2-5 MOS 晶体管高频小信号模型 2.2.2 器件电容大小的详细讨论 下面我们对图 2-5 中 MOS 晶体管高频小信号模型中的各个器件电容进行比较详细 的讨论: (1) 栅寄生电容 Cgs 和 Cgd 栅寄生电容包括栅源电容 Cgs 和栅漏电容 Cgd,在不同工作区域时,Cgs 和 Cgd大小 会发生变化,所以我们将根据晶体管的不同工作区域来讨论这两个电容的大小。 G B D Cgs Cgb Csb Cgd Cdb S 图 2-6 MOS 晶体管器件电容

单管和双管放大器的频响分析 线性区: Cp-Cm-CoWL+Co (2.1) 2 其中Cv为栅与源(漏)的交叠电容, Cov=WLoCox (2.2) 弱反型区: Cgs =Cgd=Cov=WLoCox (2.3) 速度饱和区: 此时的栅寄生电容需要推导才能得出,沟道中的沟道电流和总电荷分别为: =WU.C..IVes-Vmcs-nVs(x)]dVes(x) (2.4) dx 和 Q=WC.S[Vcs-Vm.Gs-nVcs(x)]dx [Vs-Vino-nVes (x)dVs(x) WiCaun VGS-VTH.GS (2.5) 号Lc.s-s) 于是 C-20-2WLC (2.6) oVes 3 从而 Cp=Cin+Cw- LCox+Cw (2.7) 3 Cgd=Cov (2.8) (2)背栅寄生电容Cbs和Cbd 在研究背栅寄生电容之前,我们需要先搞清楚源极、漏极寄生结电容Csbt和Cbt, 它们的大小分别为: Cbt=ACsn+尸SMwb (2.9) 和 Cat=ACan+PR。Cwdb (2.10) 其中As和AD分别为源和漏的底部面积,Ps和PD分别为源和漏的侧壁周长。 8
单管和双管放大器的频响分析 8 线性区: ox gs gd ov 2 C WL C C C (2.1) 其中 Cov 为栅与源(漏)的交叠电容, C WL C ov ov ox (2.2) 弱反型区: C C C WL C gs gd ov ov ox (2.3) 速度饱和区: 此时的栅寄生电容需要推导才能得出,沟道中的沟道电流和总电荷分别为: CS D n ox GS TH,GS CS d ( ) [ ( )] d V x I Wμ C V V nV x x (2.4) 和 GS TH,GS T ox GS TH,GS CS 0 2 2 2 ox n GS TH,GS CS CS 0 D ox GS TH,GS d d ( ) 2 3 L V V n Q WC V V nV x x W C μ V V nV x V x I WLC V V (2.5) 于是 T gs ox GS ' 2 3 Q C WLC V (2.6) 从而 gs gs ov ox ov ' 2 3 C C C WLC C (2.7) C C gd ov (2.8) (2) 背栅寄生电容 Cbs 和 Cbd 在研究背栅寄生电容之前,我们需要先搞清楚源极、漏极寄生结电容 Cjsbt 和 Cjdbt, 它们的大小分别为: C A C P C jsbt S jsb S jwsb (2.9) 和 C A C P C jdbt D jdb D jwdb (2.10) 其中 AS和 AD分别为源和漏的底部面积,PS和 PD分别为源和漏的侧壁周长

第二章单管电路低频特性以及晶体管电容 源极和漏极的下极板结电容分别为: (2.11) 和 (2.12) 源极和漏极的侧壁结电容分别为: (2.13) 1+ 中 和 (2.14) m 1 中o 其中m=1/3~1/2 搞清楚源极、漏极寄生结电容之后,我们可以根据不同工作区域来讨论背栅寄生电 容Cbs和Cbd 线性区: 1 2 (2.15) 1 (2.16) 2 饱和区和速度饱和区: C如3 (2.17) Cdb=Cjdbt (2.18) 弱反型区 Cgb=Cjsbt (2.19) Cab=Cjdbt (2.20) (3)栅-衬底电容Cgb 栅衬底电容Cgb包括两部分:栅氧化层电容Cox和耗尽层电容Cbc的串联,以及交 9
第二章 单管电路低频特性以及晶体管电容 9 源极和漏极的下极板结电容分别为: j jsb sb 0 1 C C V Φ (2.11) 和 j jdb db 0 1 C C V Φ (2.12) 源极和漏极的侧壁结电容分别为: jw jwsb sb 0 1 m C C V Φ (2.13) 和 jw jwdb db 0 1 m C C V Φ (2.14) 其中 m=1/3~1/2 搞清楚源极、漏极寄生结电容之后,我们可以根据不同工作区域来讨论背栅寄生电 容 Cbs 和 Cbd 线性区: sb bc jsbt 1 2 C C C (2.15) db bc jdbt 1 2 C C C (2.16) 饱和区和速度饱和区: sb bc jsbt 2 3 C C C (2.17) C C db jdbt (2.18) 弱反型区 C C sb jsbt (2.19) C C db jdbt (2.20) (3) 栅-衬底电容 Cgb 栅衬底电容 Cgb 包括两部分:栅氧化层电容 Cox 和耗尽层电容 Cbc 的串联,以及交
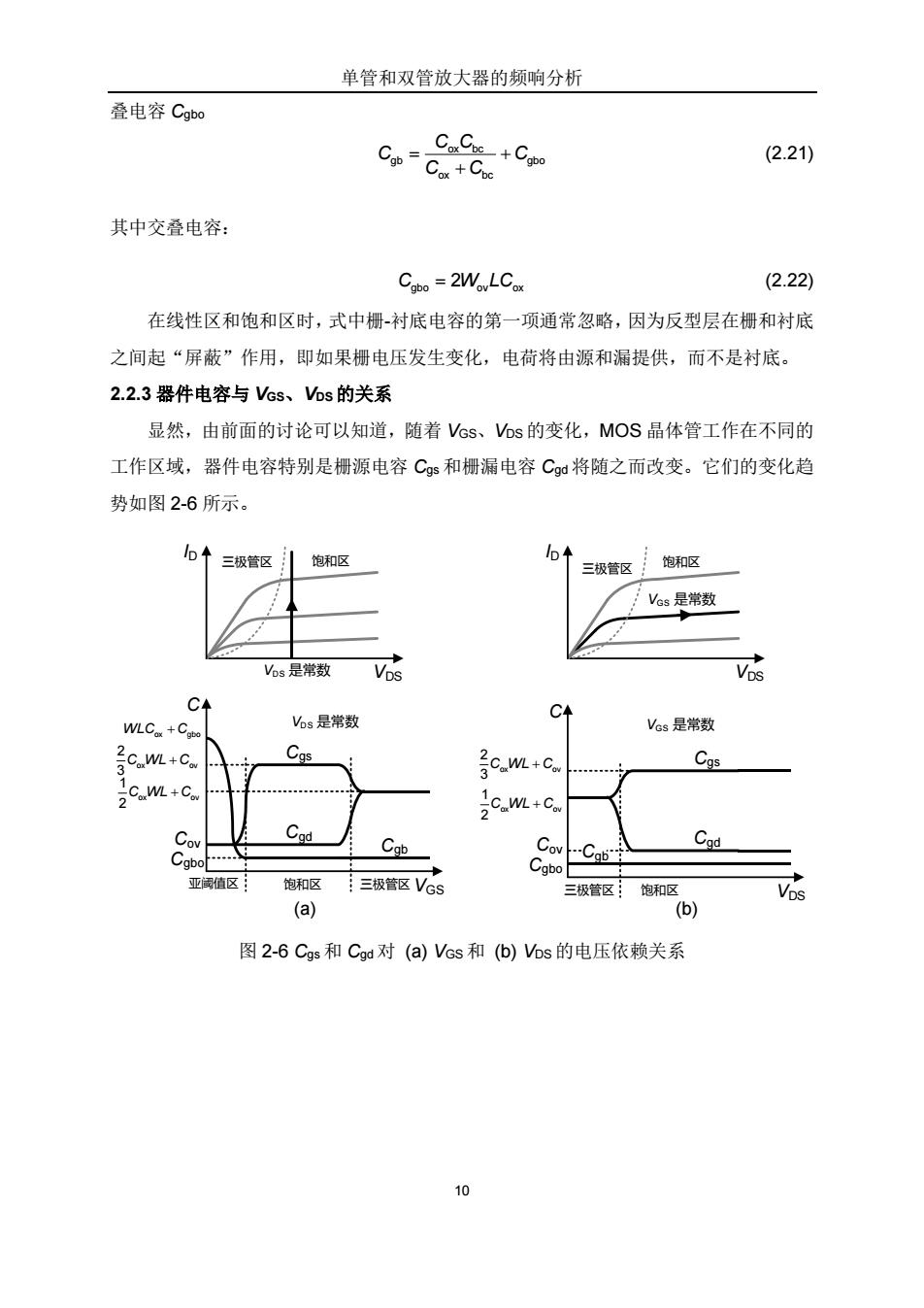
单管和双管放大器的频响分析 叠电容Cgbo CoCvc_+Cgbo (2.21) Cox +Coc 其中交叠电容: Cgbo=2WovLCox (2.22) 在线性区和饱和区时,式中栅-衬底电容的第一项通常忽略,因为反型层在栅和衬底 之间起“屏蔽”作用,即如果栅电压发生变化,电荷将由源和漏提供,而不是衬底。 2.2.3器件电容与Vcs、Vbs的关系 显然,由前面的讨论可以知道,随着V6s、VDs的变化,MOS晶体管工作在不同的 工作区域,器件电容特别是栅源电容Cgs和栅漏电容Cg将随之而改变。它们的变化趋 势如图2-6所示。 三极管区川 饱和区 三极管区 饱和区 V%s是常数 Vos是常数 Vos Vos C V%s是常数 CA WLCo+Cobo Ves是常数 _WL+C. Cgs 2 3 .WL+C Cgs 2C.WL+C 1c_WL+C. CoN Cgd Cov Cgd Cgbo- Cap Cgbo 亚阈值区: 饱和区 :三极管区VGs 三极管区: 饱和区 Vps (a) (b) 图2-6Cgs和Cgd对(a)Vcs和(b)Vbs的电压依赖关系 10
单管和双管放大器的频响分析 10 叠电容 Cgbo ox bc gb gbo ox bc C C C C C C (2.21) 其中交叠电容: C W LC gbo ov ox 2 (2.22) 在线性区和饱和区时,式中栅-衬底电容的第一项通常忽略,因为反型层在栅和衬底 之间起“屏蔽”作用,即如果栅电压发生变化,电荷将由源和漏提供,而不是衬底。 2.2.3 器件电容与 VGS、VDS的关系 显然,由前面的讨论可以知道,随着 VGS、VDS的变化,MOS 晶体管工作在不同的 工作区域,器件电容特别是栅源电容 Cgs 和栅漏电容 Cgd 将随之而改变。它们的变化趋 势如图 2-6 所示。 (a) (b) ID VDS ID VDS C VDS VG S 是常数 Cgd Cgs Cov Cgb Cgbo VGS C Cov VD S 是常数 Cgs Cgd Cgbo Cgb 亚阈值区 饱和区 三极管区 三极管区 饱和区 饱和区 饱和区 三极管区 三极管区 VD S 是常数 VG S 是常数 图 2-6 Cgs 和 Cgd 对 (a) VGS和 (b) VDS的电压依赖关系 ox ov 2 3 C WL C ox ov 1 2 C WL C ox ov 2 3 C WL C WLC C ox gbo ox ov 1 2 C WL C