
忽约x<0的重掺杂P区,则空间电荷区从x=0到x=d,泊松 方程可以写为: d'v plx) Bxm dx2 EoEsi EoEsi 将上式积分两次,利用边界条件 x=0,V(0)=0,x=d,V(d)=VD-V,E(d=0,得到耗尽层厚度和势 垒电容的表示式如下: Ess(m+2yo-V) m+2 d= qB =A 9B(m1 m+2 m+2 (m+2w。- c-
• 忽约x<0的重掺杂P区,则空间电荷区从x=0到x=d,泊松 方程可以写为: • 将上式积分两次,利用边界条件 x=0, V(0)=0; x=d, V(d)=VD-V, E(d)=0,得到耗尽层厚度和势 垒电容的表示式如下: m Si Si Bx x q dx d V 0 0 2 2 2 1 0 2 m Si D qB m V V d 2 1 0 2 1 1 0 1 2 m D j m D m Si j V V C m V V qB C A

可以看出,PN结势垒电容的非线性和杂质浓度的分布 有密切的关系。杂质浓度分布越陡且斜率为正(越大) ,则电容随外加偏压的变化就越小。而对<0的超突变 结,其电容的变化最大。 +-70μm+ 1'2020 p 10 n+ n+ 4μn SiQ2 11018 n 11027 150-200μm 11016 1105 n+衬底 11024 e2 3 与表面距离(从m)
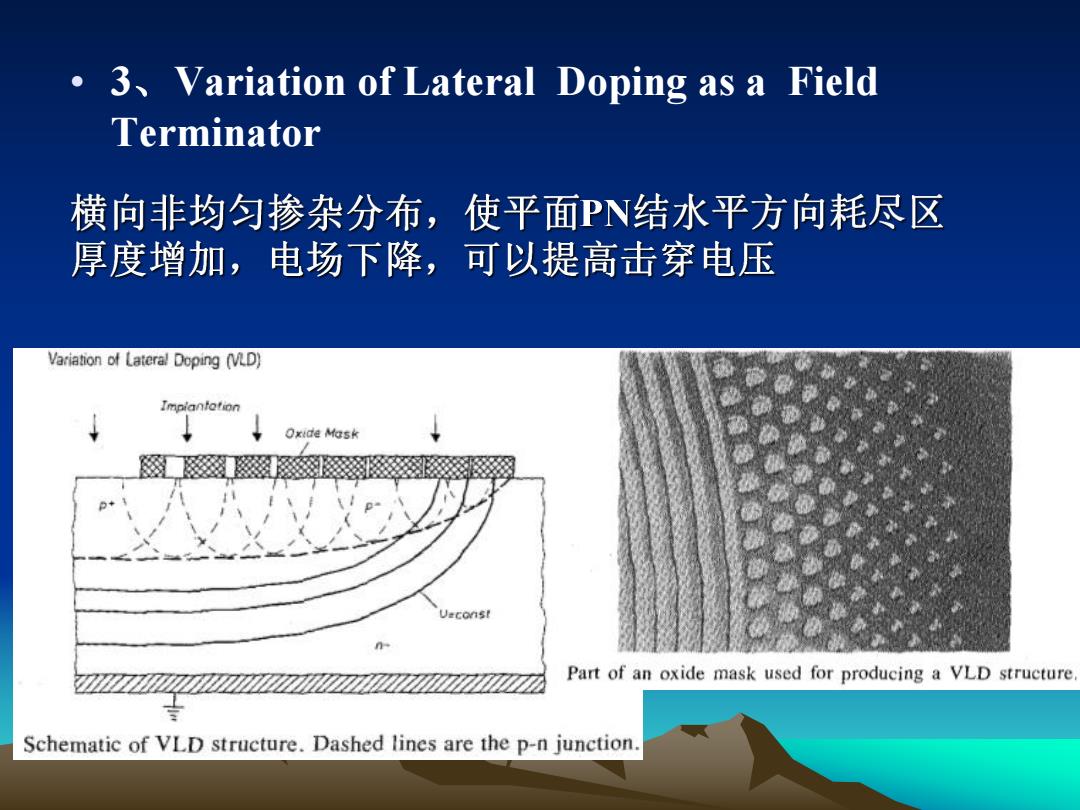
·3、Variation of Lateral Doping as a Field Terminator 横向非均匀掺杂分布,使平面PN结水平方向耗尽区 厚度增加,电场下降,可以提高击穿电压 Variation of Lateral Doping (VLD) Implantotion Oxide Mask Ueconst Part of an oxide mask used for producing a VLD structure Schematic of VLD structure.Dashed lines are the p-n junction
• 3、Variation of Lateral Doping as a Field Terminator
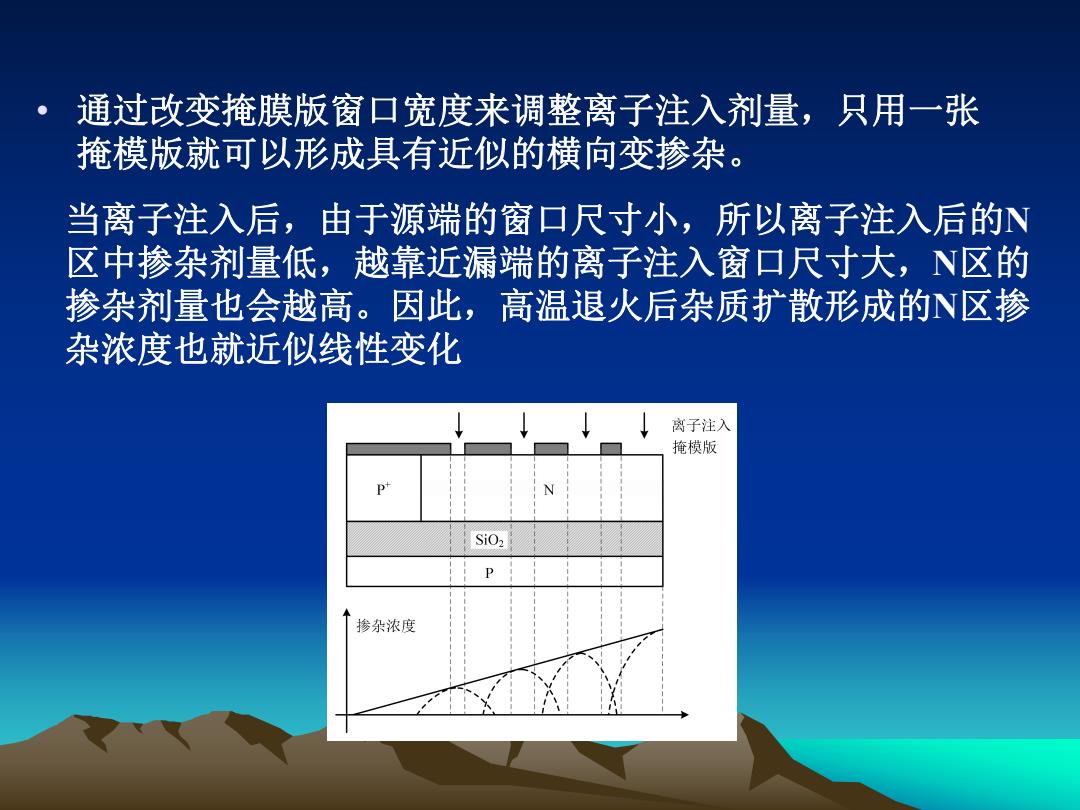
通过改变掩膜版窗口宽度来调整离子注入剂量,只用一张 掩模版就可以形成具有近似的横向变掺杂。 当离子注入后,由于源端的窗口尺寸小,所以离子注入后的N 区中掺杂剂量低,越靠近漏端的离子注入窗口尺寸大,N区的 掺杂剂量也会越高。因此,高温退火后杂质扩散形成的N区掺 杂浓度也就近似线性变化 离子注入 掩模版 掺杂浓度
• 通过改变掩膜版窗口宽度来调整离子注入剂量,只用一张 掩模版就可以形成具有近似的横向变掺杂。 当离子注入后,由于源端的窗口尺寸小,所以离子注入后的N 区中掺杂剂量低,越靠近漏端的离子注入窗口尺寸大,N区的 掺杂剂量也会越高。因此,高温退火后杂质扩散形成的N区掺 杂浓度也就近似线性变化
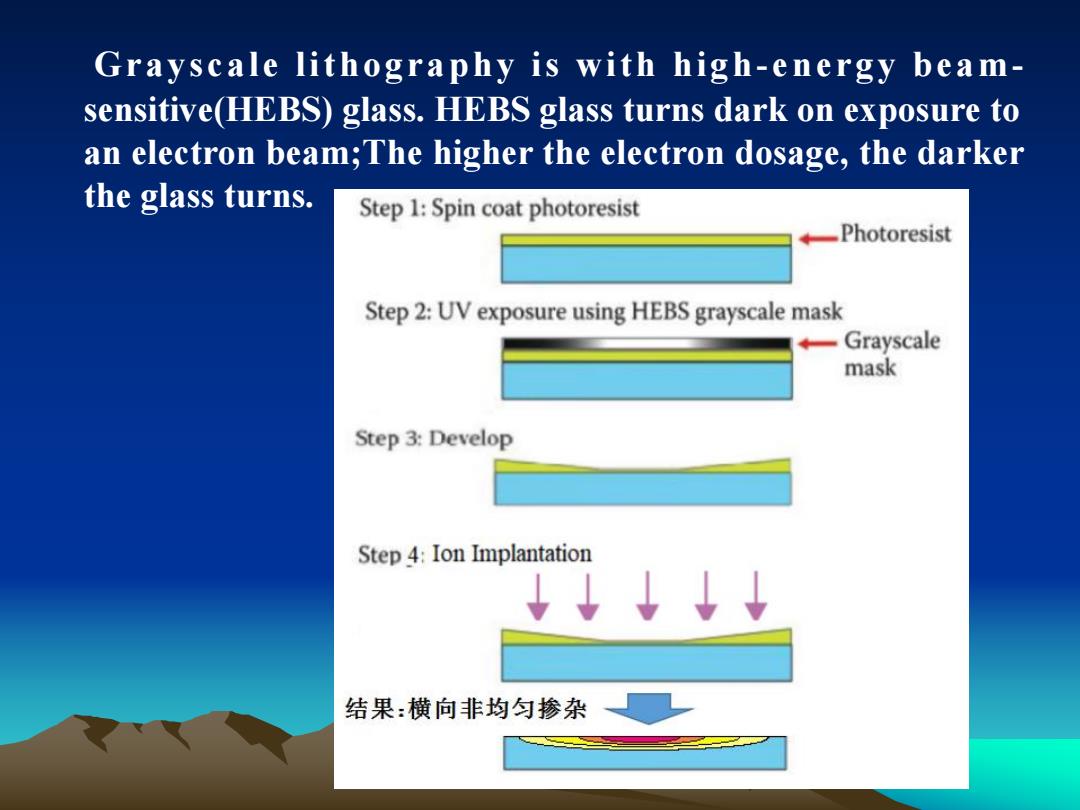
Grayscale lithography is with high-energy beam- sensitive(HEBS)glass.HEBS glass turns dark on exposure to an electron beam;The higher the electron dosage,the darker the glass turns. Step 1:Spin coat photoresist Photoresist Step 2:UV exposure using HEBS grayscale mask ◆Grayscale mask Step 3:Develop Step 4:Ion Implantation ↓↓↓↓↓ 结果:横向非均匀掺杂
Grayscale lithography is with high-energy beam- sensitive(HEBS) glass. HEBS glass turns dark on exposure to an electron beam;The higher the electron dosage, the darker the glass turns