
第五章纳米CMOS器件的沟道工程和超浅结技术 ·MOS器件特征尺寸进入纳米领域时,ULSI的严重限制性 因素: 1.短沟道效应(SCE: Short Channel Effect) 2.源—漏穿通 3.热载流子效应(HCE: Hot Carrier Effect) ·解决办法:沟道工程和超浅结技术 ·沟道工程对沟道进行的非单一、非均匀化的特殊局域 掺杂的杂质分布和结构。有沟道逆向掺杂,HALO结构, 介质pocket
• MOS器件特征尺寸进入纳米领域时, ULSI的严重限制性 因素: 1.短沟道效应(SCE:Short Channel Effect) 2.源—漏穿通 3.热载流子效应(HCE:Hot Carrier Effect) • 解决办法:沟道工程和超浅结技术 • 沟道工程——对沟道进行的非单一、非均匀化的特殊局域 掺杂的杂质分布和结构。有沟道逆向掺杂,HALO结构, 介质pocket

基本概念 沟道逆向掺杂:MOSFET沟道处的掺杂必须和源、漏的极 性相反,但沟道处掺杂浓度高了,阈值电压增加,反型就 变得困难;而且出现杂质随机分布和迁移率退化。而掺杂 浓度低或不掺杂,短沟道效应又会更明显,穿通泄漏的可 能也越大。逆向掺杂则取了个折衷,接近栅极的沟道表面 几乎不掺杂,往衬底的方向则增加掺杂浓度。这样沟道表 面的载流子迁移率仍然高,不影响开通时的电流,而截止 时整体的泄漏电流却可以减少。利用参杂浓度的不同,还 能对阀值电压作一定的控制
• 基本概念 • 沟道逆向掺杂:MOSFET沟道处的掺杂必须和源、漏的极 性相反,但沟道处掺杂浓度高了,阈值电压增加,反型就 变得困难;而且出现杂质随机分布和迁移率退化。而掺杂 浓度低或不掺杂,短沟道效应又会更明显,穿通泄漏的可 能也越大。逆向掺杂则取了个折衷,接近栅极的沟道表面 几乎不掺杂,往衬底的方向则增加掺杂浓度。这样沟道表 面的载流子迁移率仍然高,不影响开通时的电流,而截止 时整体的泄漏电流却可以减少。利用掺杂浓度的不同,还 能对阀值电压作一定的控制
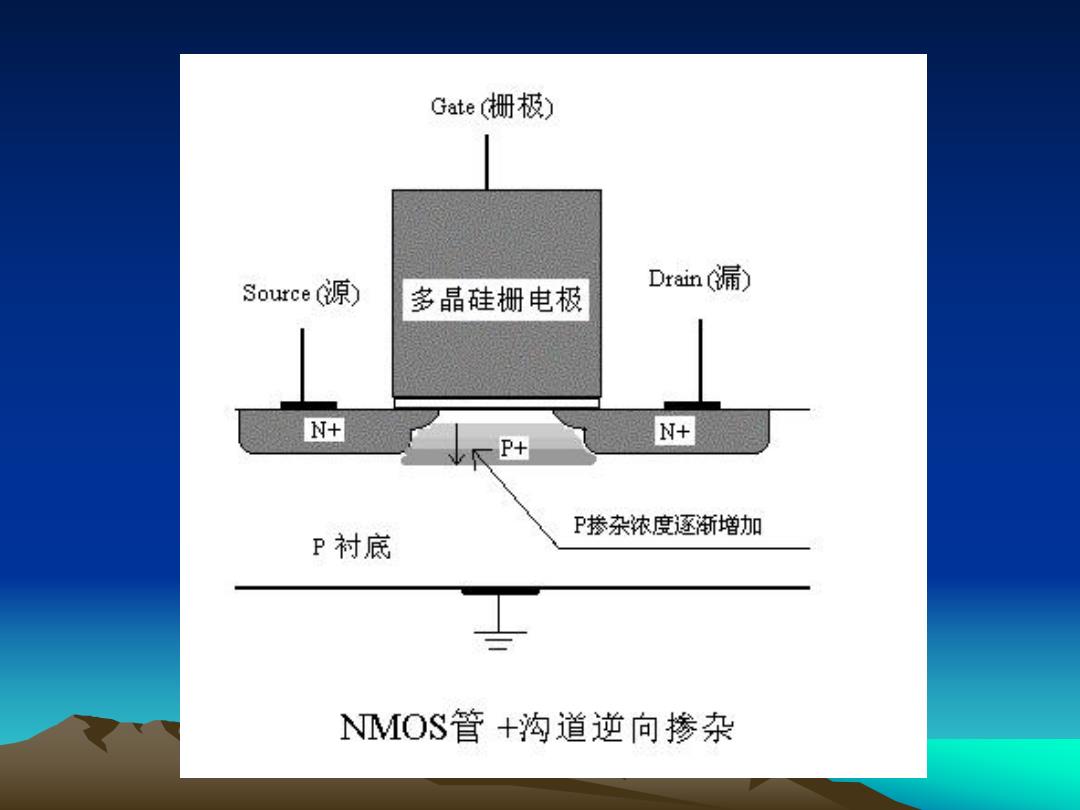
Gate(栅极) Source(源) Drain漏) 多晶硅栅电极 N+ N+ P+ P掺杂浓度逐渐增加 P衬底 NMOS管+沟道逆向掺杂

HALO结构:与逆向掺杂从纵向处理沟道区域不同, ALO结构是仅在源和漏附近增加沟道掺杂的浓度,也能 起到相似的效果。 Gate栅极) Source(源) Drain(漏) 多晶硅栅电极 N+ N+ HALO P衬底 NMOS管+HALO
• HALO结构: 与逆向掺杂从纵向处理沟道区域不同, HALO结构是仅在源和漏附近增加沟道掺杂的浓度,也能 起到相似的效果

介质pocket:介质pocket.则是用绝缘介质替代HALO结构, 它减少了注入掺杂可能带来的问题,如掺杂浓度难以控制、 离子注入带来损伤,载流子迁移率改变等 Gate(栅极) Source(源) Drain(漏) 多晶硅栅电极 N+ N+ 介质pocket P衬底 NMOS管+介质pocket
• 介质pocket: 介质pocket则是用绝缘介质替代HALO结构, 它减少了注入掺杂可能带来的问题,如掺杂浓度难以控制、 离子注入带来损伤,载流子迁移率改变等