
由图5.1可知,在逆向掺杂纳米MOS器件的沟道区内,在位 于表面的N区,泊松方程可写为 d(x,y),d4(x,y)_ qNa dx2 dy2 EoEsi 而在作为埋层的N2区,则可写为 d22(x,y)d4(x,y)_qN42 dx2 dy" EoEsi 坐标为:y轴垂直于沟道方向,x轴平行于沟道方向。 如果假设表面N,区的电势分布为抛物线型(如下),埋层 N2区的电势分布为立方型,通过解上述的耦合方程可以得 到沟道表面势的二次微分方程 (x,y)co(x)+c(x)y+c,(x)v
• 由图5.1可知,在逆向掺杂纳米MOS器件的沟道区内,在位 于表面的NA1区,泊松方程可写为 • 而在作为埋层的NA2区,则可写为 坐标为:y轴垂直于沟道方向,x轴平行于沟道方向。 • 如果假设表面NA1区的电势分布为抛物线型(如下),埋层 NA2区的电势分布为立方型,通过解上述的耦合方程可以得 到沟道表面势的二次微分方程 2 2 1 1 1 2 2 0 ( , ) ( , ) A si d x y d x y qN dx dy 2 2 2 2 2 2 2 0 ( , ) ( , ) A si d x y d x y qN dx dy
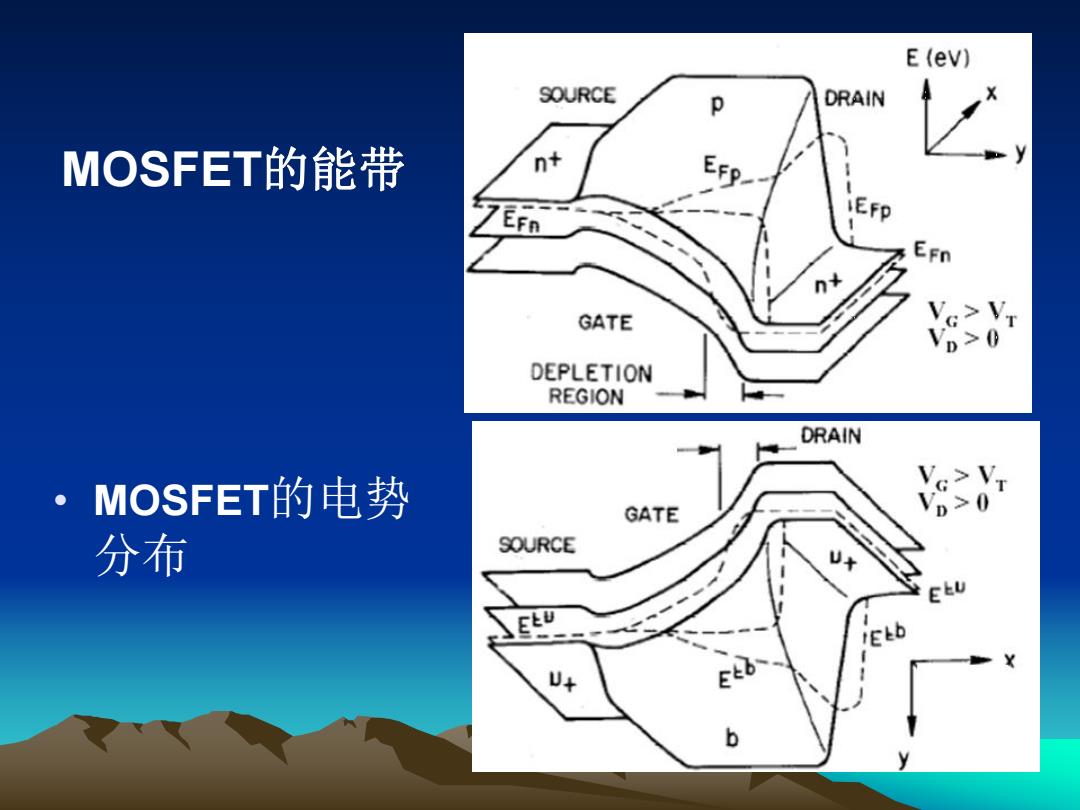
E(ev) SOURCE DRAIN MOSFET的能带 n+ F EFP EFn GATE G>VT V>0 DEPLETION REGION DRAIN VOSFET的电势 VG>VT GATE VD>0 分布 SOURCE U+ b
• MOSFET的电势 分布 MOSFET的能带

d典+-4-9Wa+ EoEs (Na-NpXd-ts)(d-ty) 23d-1(V+V Es d(d+t)d(d+ty) 。 式中,t为低浓度的N掺杂层的外延层厚度;为Vc'栅电 压减去平带电压后的有效栅电压,V、b为衬底电压,d为 短沟道逆向掺杂结构栅下的有效最大的耗尽层宽度: La 人dm 1-2exp 5(x3+xD) 。 式中,xs、n分别为源端和漏端耗尽层宽度,xm是长沟 道逆向掺杂结构MOSFETZ栅下的最大耗尽层宽度,L是 栅长,是拟合参数,一般取0.65
• 式中,t si为低浓度的NA1掺杂层的外延层厚度;为VG ’栅电 压减去平带电压后的有效栅电压,Vsub为衬底电压,d为 短沟道逆向掺杂结构栅下的有效最大的耗尽层宽度: • 式中,xS、xD分别为源端和漏端耗尽层宽度,xdm是长沟 道逆向掺杂结构MOSFET栅下的最大耗尽层宽度,LG是 栅长,ξ是拟合参数,一般取0.65。 2 ' 1 2 2 0 s G s A si d V qN dx 3 3 1 2 ' 2 2 ( )( ) ( ) 2(3 ) ( ) ( ) ( ) A A si si si G sub si si si q N N d t d t d t V V d d t d d t 1 1 2exp ( ) dm G S D d x L x x

用特征长度)表示该结构的短沟效应,由下式决定: Eytard2(d+ly) 2812d2+8/Eoto (3d-ts)] 假定Lc≥,则逆向掺杂沟道纳米MOS器件的V,'可以表达 为 1-2 (3xm-tm)22 2exp( ,三 (xa+ta) 1-23d-) Vio- (3d-tsi) V(W-2e)'-2φe+'o) d2(d+tg) 1-2 d2(d+t) V、'为阈值电压V-减去平带电压后的值,长沟道的逆向掺 杂沟道MOS器件的Vro'为 25.6.qN2c+V+9CN-Nacj-q(N.p-N. 280Esi
• 用特征长度λ表示该结构的短沟效应, λ由下式决定: • 假定LG≥λ,则逆向掺杂沟道纳米MOS器件的VT ’可以表达 为 • VT ’为阈值电压VT减去平带电压后的值 ,长沟道的逆向掺 杂沟道MOS器件的 VTO ’为 2 2 ( ) 2 [2 / (3 )] si ox si ox si ox ox si t d d t d t d t 2 2 ' ' 2 2 2 (3 ) 1 2 2exp( ) ( ) (3 ) (3 ) 1 2 1 2 ( ) ( ) dm si G dm dm si T TO si si si si x t L x x t V V d t d t d d t d d t ( 2 )( 2 ) Vbi F Vbi F VD ' 2 1 2 0 2 2 1 0 0 1 ( ) 2 2 [2 ] ( ) 2 A A TO F si A F sub si A A si x si q N N V qN V t q N N t C

如果逆向掺杂沟道纳米MOS结构的外延层厚度满足如下 关系: 2e1 (24。+'u) Nq(N-Na) 阈值电压公式可以进一步简化。 图5.2是数值分析和理论V,模型所预言的逆向掺杂沟道纳 米MOS器件在不同浓度的N掺杂层时,V随外延层厚度 的变化关系。从该图中可以发现:该结构的V随外延层厚 度的减小而上升,这个关系与沟道长度对V的影响正相反。 另一方面,可以观察到:理论模型得到的V变化与数值分 析的结果基本一致,也证明了理论假设的正确性
• 如果逆向掺杂沟道纳米MOS结构的外延层厚度满足如下 关系: 阈值电压公式可以进一步简化。 • 图5.2 是数值分析和理论VT模型所预言的逆向掺杂沟道纳 米MOS器件在不同浓度的NA2掺杂层时,VT随外延层厚度 的变化关系。从该图中可以发现:该结构的VT随外延层厚 度的减小而上升,这个关系与沟道长度对VT的影响正相反。 另一方面,可以观察到:理论模型得到的VT变化与数值分 析的结果基本一致,也证明了理论假设的正确性