
9.2.2溅射法 利用固体表面溅出来的物质沉积成膜的过程,称度镀膜。悲溅附法镀膜是利用气本 放电产生的正离子,在电场作用下加速成为高能粒子,撞击膜材料(称为靶)的表面,进 行能量和动量交换后,膜材料的原子或分子脱离膜材料表面并沉积在基片上形成薄膜。烖 射镀膜基于高能粒子轰击靶材时的溅射效应,而整个溅射过程都是建立在辉光放电的基础 上。不同的斐射枝术采用不同的辉光放电方式,如直流戏射建立在直流辉光放电的基础上, 射频溅射利用射频辉光放电,磁控溅射则是利用环状磁场控制下的辉光放电 贱射糖膜是以高能粒子与膜材料之间的动量交换为主,溅出来的粒子的平均能量在 10V左右或更高,而蒸发镀膜以能量交换为主,是热的作用使膜材料以原子或分子形态 进入气相,粒子的平均能量一般只有0.2V。粒子能量高有利于提高膜层与基片的附着强 度,而且沉积的粒子在基片表面的迁移率也大,有利于形成致密的薄膜。溅射镀膜还有其 他优点:①对于任何待镀材料,只要能作成靶材,就可实现溅射:②溅射所获得的薄膜纯 度高:③溅射工艺可重复性好,膜厚可控制,同时可以在大面积基片上获得厚度均匀的调 膜。缺点是,相对于真空蒸发,溅射镀膜的沉积速率低,基片会受到等离子体的辐照等作 用而产生温升 溅射法可以镀制金属膜,如Ti、Cu、Al、Cr、Sn、In、Ag、Au、Bi等,合金膜,以 及卤化物、碲化物、氮化物、碳化物、硼化物、硒化物的薄膜等:可镀制多层膜,如基片 /金属/氧化物(或氨化物)膜、基片金属/金属/氧化物膜、基片氧化物/金属/氧化物(或氨 化物)膜等。目前,溅射法已大量应用,生产工艺稳定,容易控制,膜厚均匀性可达1%, 有替代蒸发法的趋势。 9.2.2.1直流溅射法 在充有惰性气体(如氩或氙)的真空室中(压力1~10Pa),施加高压电场(直流1~5kV) 阴极靶(膜材料)上的负高压使惰性气体电离,在阴极靶和阳极(成膜基片及其支架)之 间产生辉光放电,形成一个等离子区,带正电的惰性气体离子流受电场加速而轰击阴极靶 使靶材产生减少,溅射出来的原子或分子沉积在基片表面。二次电子飞向阳极的行程中, 与气体分子碰撞并使之电离,使辉光放电过程得以维持,从而实现溅射薄膜。二极直流溅 射系统是最简单的直流溅射系统(见图97),在此基础上发展起来的三级和四极溅射系统, 镀膜效明显提高。 9.2.2.2磁控溅射法 磁控溅射法是在直流溅射法的基础上发展起米的,其原理如图9-8所示。此法在阴极 和阳极之间增设了永久磁铁,在阴极靶上方形成一个正交电磁场,称为磁增强阴极。在此 情形下,等离子体被约束在磁力线影响的区域内,使电离增加,在阴极附近形成高密度的 等离子体,从而有更多的正离子轰击膜材料,提高了溅射速度,如一般阴极溅射率 0.7 mg/s-kW,而平面磁控溅射*可达7 mg/s.Kw。磁控溅射法避免了直流溅射法沉积速低 基片温度升高等缺点,并具有可控性、重复性好等优点。缺点是靶材利用率不高。 磁控溅射法按溅射源的类型可分为平面磁控溅射、圆柱面磁控溅射和$枪磁控溅射等 玻璃工业采用平面磁控溅射法制备镀膜玻璃,玻璃的尺寸最大可达60O0mmx3180mm。 9.2.2.3 射频溅射法 由于直流溅射是以靶材为阴极,因此只能溅射导电材料。对绝缘材料可采用射频溅射 法。由于绝缘体靶表面上的离子和电子交互撞击,使靶体表面不会蓄积正电荷,因而可以 11
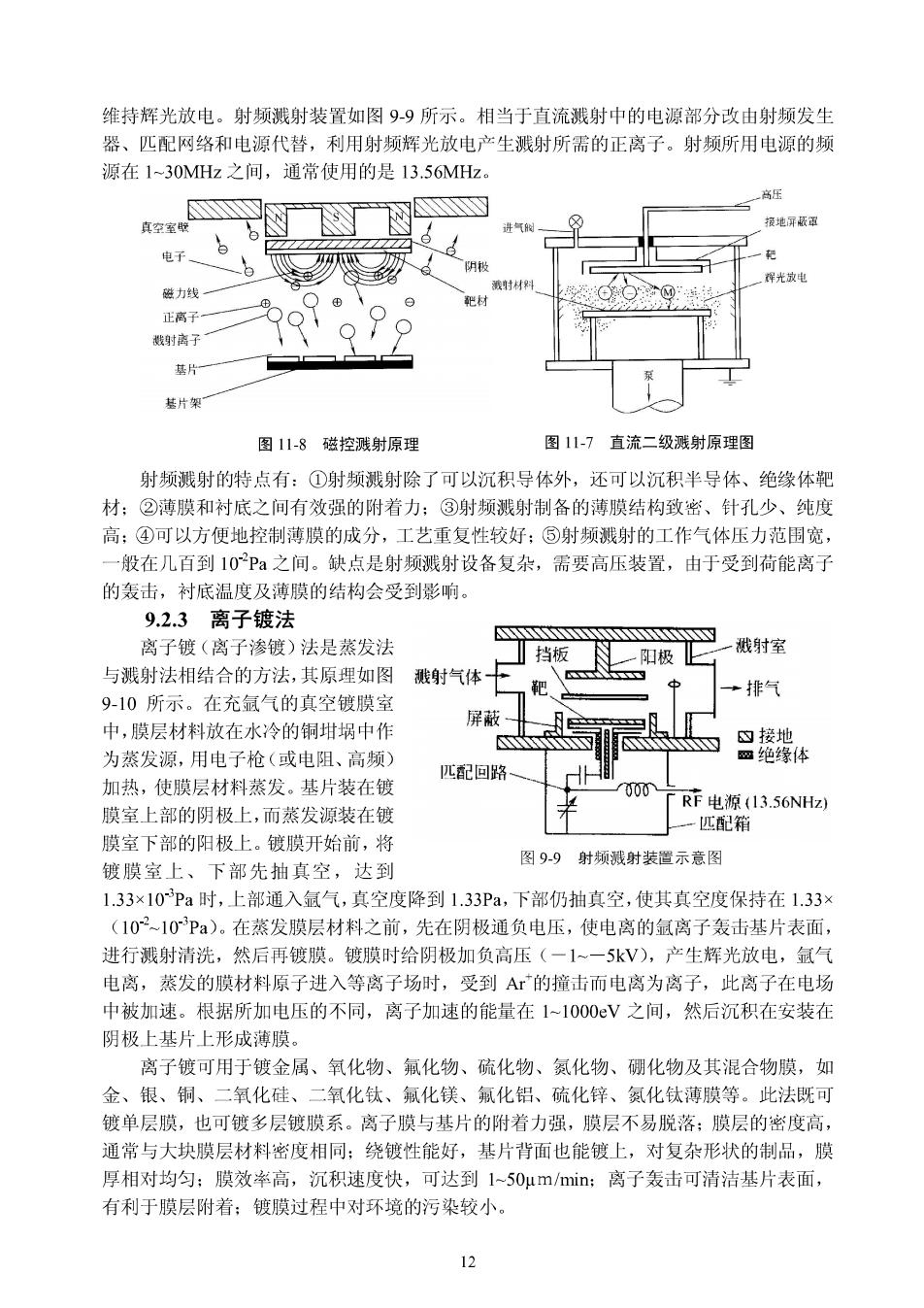
维持辉光放电。射频溅射装置如图9-9所示。相当于直流溅射中的电源部分改由射频发生 器、匹配网络和电源代替,利用射频辉光放电产生溅射所需的正离子。射频所用电源的频 源在1~30MHz之间,通常使用的是13.56MHz 直方 地质罩 电子、 6外w 力线 Q 离 基片一 基片絮 图11-8磁控溅射原理 图11-7直流二级溅射原理图 射频溅射的特点有:①射频溅射除了可以沉积导体外,还可以沉积半导体、绝缘体靶 材:②海膜和衬底之间有效强的附着力;③谢频溅射制备的薄膜结构致密、针孔少、纯度 高:④可以方便地熔制薄隙的成分,工艺重复性校好:⑤射频悲射的工作气体压力带用宽 般在几百到10Pa之间。缺点是射颊溅射设备复杂,需要高压装置,由于受到荷能离了 的轰击,衬底温度及薄膜的结构会受到影响。 9.2.3离子镀法 离子镀(离子途辩)法是旅发法 档板 一阳极 一機射室 与溅射法相结合的方法,其原理如图 非射气体 排气 9-10所示。在充氩气的真空镀膜室 中,膜层材树科放在水令的铜坩锅中作 为蒸发源,用电子枪(或电阻、高频) 匹配回路 加热,使模层材料蒸发。其片转在度 RF电源(I3.56NHz 膜室上部的阴极上,而蒸发源装在镀 一匹配箱 膜室下部的阳极上。镀膜开始前,将 镀膜室上、下部先抽真空,达到 图9-9射频溅射装置示意图 1.33×103Pa时,上部通入氩气,真空度降到1.33Pa,下部仍抽真空,使其真空度保持在1.33× (1010Pa)。在蒸发膜层材料之前,先在阴极通负电压,使电离的氩离子轰击基片表面 进行溅射清洗,然后再镀膜。镀膜时给阴极加负高压(一1~一5kV),产生辉光放电,氩气 电离,蒸发的膜材料原子进入等离子场时,受到A的撞击而电离为离子,此离子在电场 中被加速。根据所加电压的不同,离子加速的能量在1~1000V之间,然后沉积在安装在 阴极上基片上形成薄膜。 离子镀可用于镀金属、氧化物、氟化物、硫化物、氯化物、硼化物及其混合物膜,如 金、银、铜、二氧化硅、二氧化钛、氟化镁、氟化铝、硫化锌、氮化钛薄膜等。此法既可 镀单层膜,也可镀多层镀膜系。离子膜与基片的附者力强,膜层不易脱落:膜层的密度高, 通常与大块膜层材料密度相同:绕镀性能好,基片背面也能镀上,对复杂形状的制品,膜 厚相对均匀:膜效率高,沉积速度快,可达到1~50μm/mi:离子轰击可清洁基片表面, 有利于膜层附着:镀膜过程中对环境的污染较小。 12