
·泄漏电流 - 泄漏电流(关态电流)无法有效抑制,为非晶硅的十至 百倍.且约有17%的LTPS良率下降来自于漏电流 - 泄漏电流产生的原因 ·有相当多的晶粒内和晶粒间缺陷 H钝化处理! ·光漏电流 导带边 高场 ·温度 热发射(与电场无关) Pool-Frenkel (与电场有关) E 光辅助隧穿 (与电场有关) 电子从深陷阱中发射入导带的过程 隧穿 (与温度无关)
• 泄漏电流 –泄漏电流(关态电流)无法有效抑制,为非晶硅的十至 百倍.且约有17%的LTPS良率下降来自于漏电流 –泄漏电流产生的原因 • 有相当多的晶粒内和晶粒间缺陷 • 光漏电流 • 高场 • 温度 隧穿 (与温度无关) 光辅助隧穿 (与电场有关) Pool-Frenkel (与电场有关) 热发射(与电场无关) 导带边 H钝化处理! 电子从深陷阱中发射入导带的过程

4.2.3热载流子效应 热载流子是指比零电场下的载流子具有更高平均动能的载流子 产生原因 一漏极横向电场增加, 载流子加速导致碰撞电离-漏极雪崩击穿-同 时伴随扭曲效应 一栅极高压,导致热载流子注入栅绝缘层一沟道热载流子 现象 长时间工作造成的老化 一载流子迁移率下降、阈值电压漂移、漏极电流降低 103 n型 Vps-0.5V 10-6 光-碧 30 0.3 偏压试验后 初始 Ves=4V, 10-9 90.1 初始 Vos=13V,1min 10 10-1 Vos(V) -12 12 16 Ves (V)
4.2.3 热载流子效应 • 热载流子是指比零电场下的载流子具有更高平均动能的载流子 • 产生原因 – 漏极横向电场增加,载流子加速导致碰撞电离-----漏极雪崩击穿----同 时伴随扭曲效应 – 栅极高压,导致热载流子注入栅绝缘层—沟道热载流子 • 现象 – 长时间工作造成的老化 – 载流子迁移率下降、阈值电压漂移、漏极电流降低 VGS(V) VDS(V) 初始 偏压试验后 VDS=0.5V n型 初始 VGS=4V, VDS=13V,1min

4.2.4Hump效应 亚阈值区出现驼峰现象 Id=Ia(main)d(edge) d(main)为多晶硅TFT的主要漏电流; 栅极边缘场 d(edge,为多晶硅边沿的等效漏电流 0 源极 B B
4.2.4 Hump 效应 • 亚阈值区出现驼峰现象 d d(main) d(edge) I I I Id(main)为多晶硅TFT的主要漏电流; I 栅极 栅极边缘场 d(edge)为多晶硅边沿的等效漏电流 源极 漏极 SiO2 多晶硅 栅极
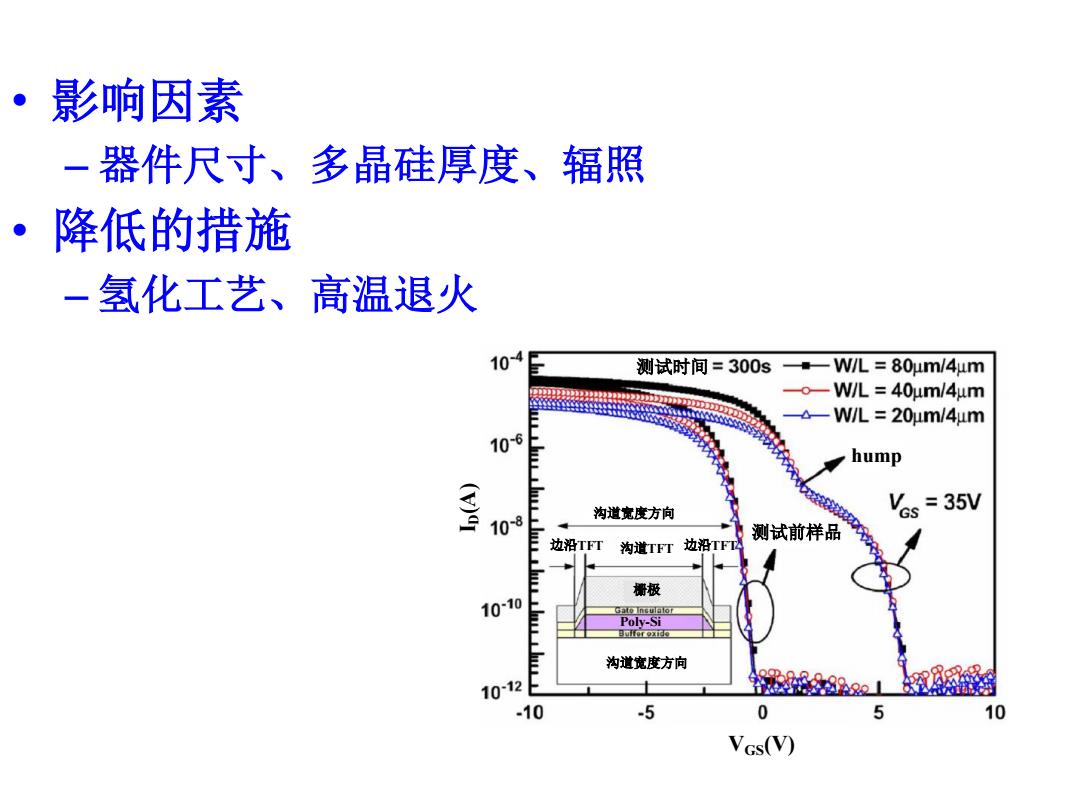
影响因素 一器件尺寸、多晶硅厚度、辐照 。 降低的措施 一氢化工艺、高温退火 104 测试时间=300s一WL=80μml4um -o-W/L 40um/4um △-WL=20μml4μm 10-6 hump 沟道宽度方向 Ves 35V 10-8 测试前样品 边沿TFT沟道TFT 边沿TFTA 帮极 10~10 Poly-Si Juffor oxide 沟道宽度方向 1012 -10 -5 0 5 10 VGs(V)
• 影响因素 – 器件尺寸、多晶硅厚度、辐照 • 降低的措施 – 氢化工艺、高温退火 VGS(V) ID(A) 测试时间 hump 测试前样品 沟道宽度方向 沟道宽度方向 栅极 边沿TFT 沟道TFT 边沿TFT Poly-Si
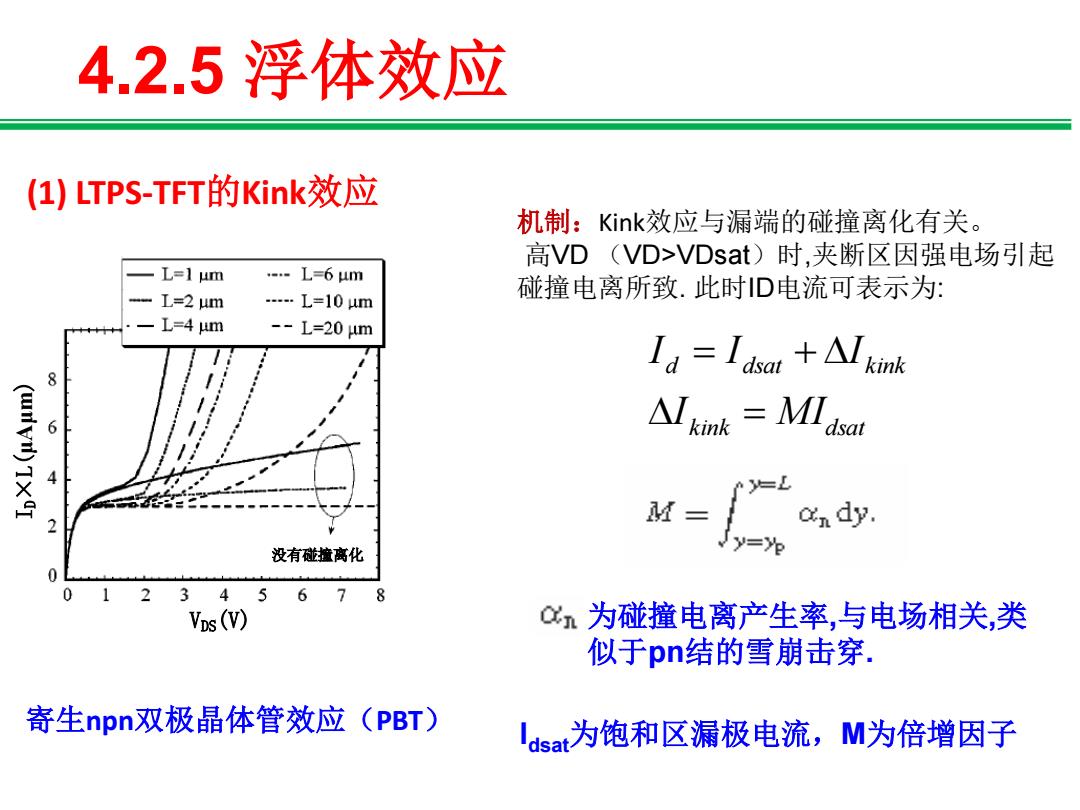
4.2.5浮体效应 (1)LTPS-TFT的Kink效应 机制:Kink效应与漏端的碰撞离化有关。 高VD(VD>VDsat)时,夹断区因强电场引起 L=1μm L=6 um 碰撞电离所致.此时D电流可表示为: L=2 um …L=10m L=4 um --L=20um Ia=Idsat+△lkk 8 AIkink-MIdsat M= andy. 没有碰撞离化 y=yp 45 678 VDs(V) c心m为碰撞电离产生率,与电场相关,类 似于pn结的雪崩击穿. 寄生npn双极晶体管效应(PBT) Idsat为饱和区漏极电流,M为倍增因子
4.2.5 浮体效应 VDS(V) I ×D L(μAμm) 没有碰撞离化 (1) LTPS-TFT的Kink效应 寄生npn双极晶体管效应(PBT) 机制:Kink效应与漏端的碰撞离化有关。 高VD (VD>VDsat)时,夹断区因强电场引起 碰撞电离所致. 此时ID电流可表示为: kink dsat d dsat kink I MI I I I 为碰撞电离产生率,与电场相关,类 似于pn结的雪崩击穿. Idsat为饱和区漏极电流,M为倍增因子