
《电子封装技术工艺综合实验》实验讲义 实验一半导体光刻实验 一、实验目的 1、掌握基本的半导体光刻实验步骤: 2、利用光刻和刻蚀将掩模板上的图形转移到衬底,完成图形转 移: 3、掌握相关光刻实验的设备的使用。 二、实验原理 2.1光刻原理及其作用 光刻就是将掩膜上的几何图形转移到覆盖在半导体晶片表面的 对光照敏感的薄膜材料(光致刻蚀剂)上去的工艺过程。这些图形确 定集成电路中的各个区域,如注入区、接触窗口区、压焊区等。由光 刻工艺确定的抗蚀剂图形并不是最后器件的构成部件,仅是电路图形 的印模,为了制备出实际的电路图形,还必须再一次把抗蚀剂图形转 移至抗蚀剂下面组成器件的材料层上,也就是使用能够对非掩膜部分 进行选择性去除的蚀刻工艺来实现图形转移。因此光刻工艺是蚀刻工 艺的前道工序,光刻对象是光照敏感的光致抗蚀剂,而蚀刻对象是能 与蚀刻剂发生反应的器件材料层,如下图的光刻流程图所示。光刻原 理与照相相似,不同的是半导体晶圆代替了照相底片,光刻胶代替了 感光涂层。光刻胶主要成分是高分子有机物,在光照下有机物分子结 构发生变化,进而使光刻胶性质发生变化,在与显影液接触时发生不
《电子封装技术工艺综合实验》实验讲义 实验一 半导体光刻实验 一、实验目的 1、掌握基本的半导体光刻实验步骤; 2、利用光刻和刻蚀将掩模板上的图形转移到衬底,完成图形转 移; 3、掌握相关光刻实验的设备的使用。 二、实验原理 2.1 光刻原理及其作用 光刻就是将掩膜上的几何图形转移到覆盖在半导体晶片表面的 对光照敏感的薄膜材料(光致刻蚀剂)上去的工艺过程。这些图形确 定集成电路中的各个区域,如注入区、接触窗口区、压焊区等。由光 刻工艺确定的抗蚀剂图形并不是最后器件的构成部件,仅是电路图形 的印模,为了制备出实际的电路图形,还必须再一次把抗蚀剂图形转 移至抗蚀剂下面组成器件的材料层上,也就是使用能够对非掩膜部分 进行选择性去除的蚀刻工艺来实现图形转移。因此光刻工艺是蚀刻工 艺的前道工序,光刻对象是光照敏感的光致抗蚀剂,而蚀刻对象是能 与蚀刻剂发生反应的器件材料层,如下图的光刻流程图所示。光刻原 理与照相相似,不同的是半导体晶圆代替了照相底片,光刻胶代替了 感光涂层。光刻胶主要成分是高分子有机物,在光照下有机物分子结 构发生变化,进而使光刻胶性质发生变化,在与显影液接触时发生不
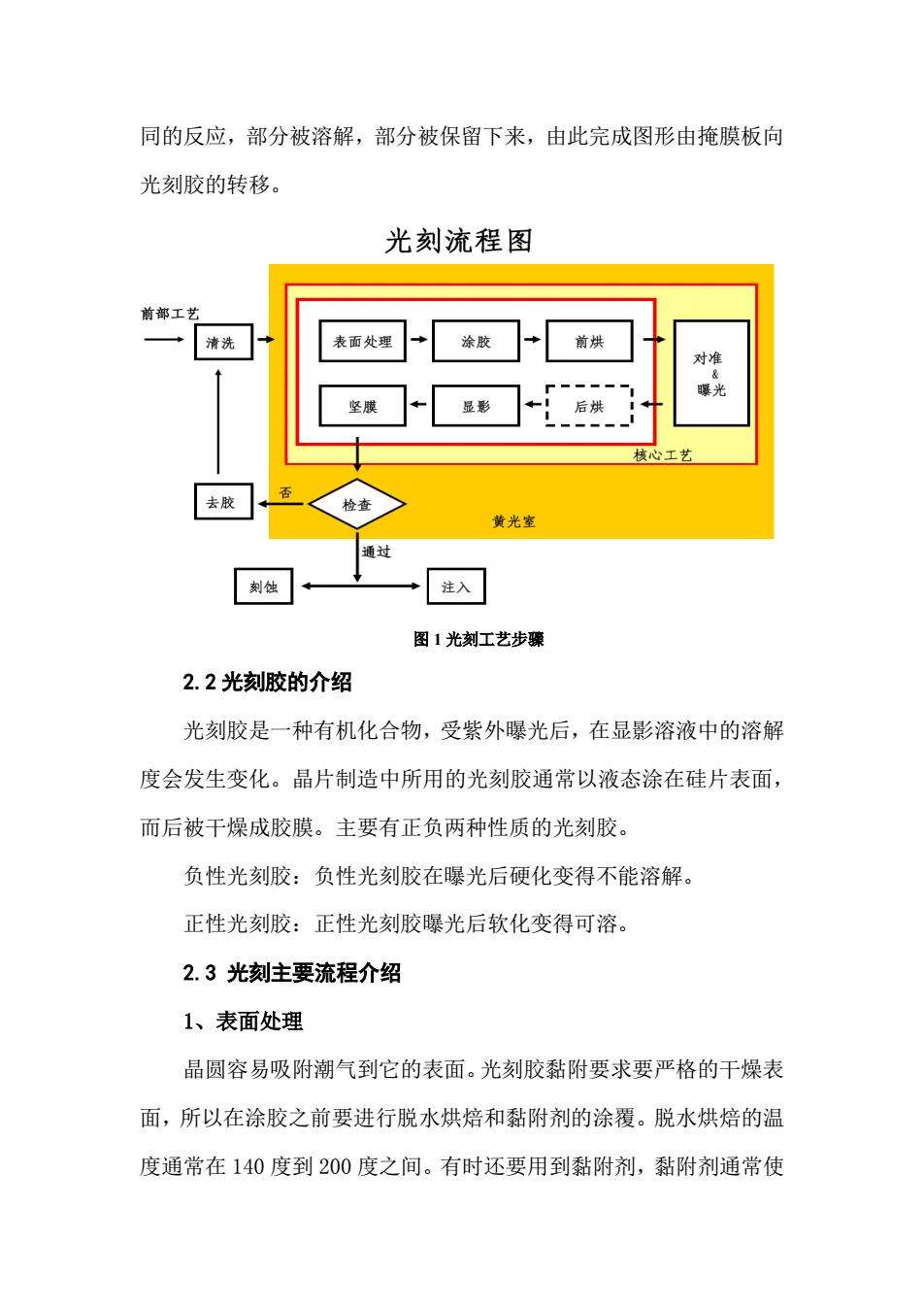
同的反应,部分被溶解,部分被保留下来,由此完成图形由掩膜板向 光刻胶的转移。 光刻流程图 前部工艺 清洗 面处理 涂胶 前烘 坚膜 显影 去胶 检查 黄光室 通过 →注入 图1光刻工艺步豫 2.2光刻胶的介绍 光刻胶是一种有机化合物,受紫外曝光后,在显影溶液中的溶解 度会发生变化。晶片制造中所用的光刻胶通常以液态涂在硅片表面, 而后被干燥成胶膜。主要有正负两种性质的光刻胶。 负性光刻胶:负性光刻胶在曝光后硬化变得不能溶解。 正性光刻胶:正性光刻胶曝光后软化变得可溶。 2.3光刻主要流程介绍 1、表面处理 晶圆容易吸附潮气到它的表面。光刻胶黏附要求要严格的干燥表 面,所以在涂胶之前要进行脱水烘焙和黏附剂的涂覆。脱水烘焙的温 度通常在140度到200度之间。有时还要用到黏附剂,黏附剂通常使
同的反应,部分被溶解,部分被保留下来,由此完成图形由掩膜板向 光刻胶的转移。 图 1 光刻工艺步骤 2.2 光刻胶的介绍 光刻胶是一种有机化合物,受紫外曝光后,在显影溶液中的溶解 度会发生变化。晶片制造中所用的光刻胶通常以液态涂在硅片表面, 而后被干燥成胶膜。主要有正负两种性质的光刻胶。 负性光刻胶:负性光刻胶在曝光后硬化变得不能溶解。 正性光刻胶:正性光刻胶曝光后软化变得可溶。 2.3 光刻主要流程介绍 1、表面处理 晶圆容易吸附潮气到它的表面。光刻胶黏附要求要严格的干燥表 面,所以在涂胶之前要进行脱水烘焙和黏附剂的涂覆。脱水烘焙的温 度通常在 140 度到 200 度之间。有时还要用到黏附剂,黏附剂通常使

用DS(六甲基二硅胺脘)。表面处理的主要作用是提高光刻胶与 衬底之间的粘附力,使之在显影过程中光刻胶不会被液态显影液渗透。 2、匀胶 匀胶时避免灰尘、小颗粒进入胶层,否则会造成有杂质的区域因 没有胶膜保护而被腐蚀掉:如果正好发生在条形台面上,会直接影响 这部分管芯的特性参数。在湿度大的季节,为保证光刻胶与基片附着 牢固,有时将片子放入表面处理剂中浸泡以增加粘附性能。 3、前烘 目的是蒸发掉胶中的有机溶剂成分,使晶圆表面的胶固化。这个 过程中胶中的溶剂基本被蒸发掉,因而通常情况下胶的厚度会变薄 (大约减少25%)。光刻胶固化,温度要适当,大约90~100度,时 间20分钟左右。 4、曝光 曝光灯的光强会随着工作时间的延长而逐渐下降,应定期监控光 强密度。光强太弱,使曝光时间不充分,在显影的时候容易留有底膜、 线条边缘不齐整。光强太强,显影速度太快,不容易控制图形。因此 要通过多次实验(曝光和显影),确定合适的曝光时间。 曝光能量=光强密度X曝光时间。 5、显影 用化学显影液将曝光造成的光刻胶的可溶解区域溶解就是光刻 胶的显影,其主要目的就是把掩膜版的图形准确复制到光刻胶中。 常见的显影液有NaOH(Shipley351),KOH(Shipley606),TMAH
用 HMDS (六甲基二硅胺脘)。表面处理的主要作用是提高光刻胶与 衬底之间的粘附力,使之在显影过程中光刻胶不会被液态显影液渗透。 2、匀胶 匀胶时避免灰尘、小颗粒进入胶层,否则会造成有杂质的区域因 没有胶膜保护而被腐蚀掉;如果正好发生在条形台面上,会直接影响 这部分管芯的特性参数。在湿度大的季节,为保证光刻胶与基片附着 牢固,有时将片子放入表面处理剂中浸泡以增加粘附性能。 3、前烘 目的是蒸发掉胶中的有机溶剂成分,使晶圆表面的胶固化。这个 过程中胶中的溶剂基本被蒸发掉,因而通常情况下胶的厚度会变薄 (大约减少 25%)。光刻胶固化,温度要适当,大约 90~100 度,时 间 20 分钟左右。 4、曝光 曝光灯的光强会随着工作时间的延长而逐渐下降,应定期监控光 强密度。光强太弱,使曝光时间不充分,在显影的时候容易留有底膜、 线条边缘不齐整。光强太强,显影速度太快,不容易控制图形。因此 要通过多次实验(曝光和显影),确定合适的曝光时间。 曝光能量=光强密度 X 曝光时间。 5、显影 用化学显影液将曝光造成的光刻胶的可溶解区域溶解就是光刻 胶的显影, 其主要目的就是把掩膜版的图形准确复制到光刻胶中。 常见的显影液有 NaOH (Shipley 351), KOH (Shipley 606) ,TMAH

(Shipley CD-26,MF-321,0CG945)等。需要注意的是:所有的这些 显影液都会刻蚀铝显影时间要适当,时间长了,会造成过显影,线条 宽度变窄、边缘坡度大、不整齐,腐蚀时容易钻蚀:显影时间短,容 易显不干净,留有底膜。显影后一定要把残留显影液、光刻胶、底膜 等漂洗干净,否则腐蚀时会出现腐蚀深度不均匀。采用等离子去胶机 处理底膜,保证显影后没有被光刻胶覆盖的区域表面干净。 6、检查 显影后在显微镜下检查显影质量,除了检查上述内容外,对于二 次光刻氧化层还要看套刻是否准确,否则漂掉光刻胶,重新涂胶光刻。 7、后烘 温度过高,会使胶变形、边缘不陡直,造成腐蚀后线条宽度变窄、 边缘不平直。 8、腐蚀 腐蚀台面深度:器件类型不同,腐蚀深度要求不同。 腐蚀氧化层:显微镜观察呈灰白色,条形边缘要平直,开孔条宽 在台面宽度之中。 9、去胶 去胶后也许仍有光刻胶底膜或胶粒,必须完全清除干净。如果一 次光刻后处理不到位,会使后面氧化层薄膜淀积附着性变差,会造成 解理时起皮;如果二次光刻后处理不到位,会使后面P面TiPtAu薄 膜淀积附着性变差,同样会造成解理时起皮、欧姆接触电阻变大。使 用等离子去胶必须通过实验控制好能量,否则会破坏外延材料表面
(Shipley CD-26, MF-321, OCG 945)等。需要注意的是:所有的这些 显影液都会刻蚀铝显影时间要适当,时间长了,会造成过显影,线条 宽度变窄、边缘坡度大、不整齐,腐蚀时容易钻蚀;显影时间短,容 易显不干净,留有底膜。显影后一定要把残留显影液、光刻胶、底膜 等漂洗干净,否则腐蚀时会出现腐蚀深度不均匀。采用等离子去胶机 处理底膜,保证显影后没有被光刻胶覆盖的区域表面干净。 6、检查 显影后在显微镜下检查显影质量,除了检查上述内容外,对于二 次光刻氧化层还要看套刻是否准确,否则漂掉光刻胶,重新涂胶光刻。 7、后烘 温度过高,会使胶变形、边缘不陡直,造成腐蚀后线条宽度变窄、 边缘不平直。 8、腐蚀 腐蚀台面深度:器件类型不同,腐蚀深度要求不同。 腐蚀氧化层:显微镜观察呈灰白色,条形边缘要平直,开孔条宽 在台面宽度之中。 9、去胶 去胶后也许仍有光刻胶底膜或胶粒,必须完全清除干净。如果一 次光刻后处理不到位,会使后面氧化层薄膜淀积附着性变差,会造成 解理时起皮;如果二次光刻后处理不到位,会使后面 P 面 TiPtAu 薄 膜淀积附着性变差,同样会造成解理时起皮、欧姆接触电阻变大。使 用等离子去胶必须通过实验控制好能量,否则会破坏外延材料表面

10、对版 一次光刻对版时要注意对准晶向,保证外延片的切边与掩膜版上 的竖线条垂直,即保证管芯解理时正好解理110自然解理面。如果 晶向未对准,会造成解理困难、无法形成很好的谐振腔、管芯特性差。 二次光刻对版时要保证与一次光刻的图形套合准确,保证氧化层 覆盖好条形台面的边缘,以防电流从条形下面流入,造成分流,使工 作电流增加、可靠性变差。设计光刻版时,加入对版标记,可以加快 对版速度、保证套合准确。 11、光刻版保养 光刻版不能有划痕和污物,光刻版的损伤会直接造成图形的不完 整、露光等,对片子成品率造成直接影响。保管时注意不要被划伤, 每次对版前必须彻底清洗,使用脱脂棉蘸少许洗涤液在去离子水下一 边冲洗一边轻轻顺线条擦拭版表面,最后用大量的去离子水冲洗干 净。 三、实验设备 实验设备:匀胶机、光刻机、烘烤机、划片机、四探针仪等。 实验材料:硅片、光刻胶、光刻掩膜板。 四、实验步骤 步骤1:硅片前烘去除水份,80摄氏度保温10分钟: 步骤2:用旋涂工艺涂上光刻胶: 匀胶机使用方法 1.将设备电源和真空泵电源打开
10、对版 一次光刻对版时要注意对准晶向,保证外延片的切边与掩膜版上 的竖线条垂直 ,即保证管芯解理时正好解理 110 自然解理面。如果 晶向未对准,会造成解理困难、无法形成很好的谐振腔、管芯特性差。 二次光刻对版时要保证与一次光刻的图形套合准确,保证氧化层 覆盖好条形台面的边缘,以防电流从条形下面流入,造成分流,使工 作电流增加、可靠性变差。设计光刻版时,加入对版标记,可以加快 对版速度、保证套合准确。 11、光刻版保养 光刻版不能有划痕和污物,光刻版的损伤会直接造成图形的不完 整、露光等,对片子成品率造成直接影响。保管时注意不要被划伤, 每次对版前必须彻底清洗,使用脱脂棉蘸少许洗涤液在去离子水下一 边冲洗一边轻轻顺线条擦拭版表面,最后用大量的去离子水冲洗干 净 。 三、实验设备 实验设备:匀胶机、光刻机、烘烤机、划片机、四探针仪等。 实验材料:硅片、光刻胶、光刻掩膜板。 四、实验步骤 步骤 1:硅片前烘去除水份, 80 摄氏度保温 10 分钟; 步骤 2:用旋涂工艺涂上光刻胶; 匀胶机使用方法 1. 将设备电源和真空泵电源打开