
IC封装设计 IC封装工艺(sip):SMT,DA,WB,Mold SMT Die Wafer Wafer Attaching Grinding Sawing Flip Chip Ball Wire Placement Molding Bonding Marking Singulation FT Packing
www.chinafastprint.com IC封装工艺(sip):SMT,DA,WB,Mold IC封装设计

IC封装设计 Substrate)加工工艺:HDI,Buiding up 绿油 金层 镍层 铜层 通孔 介电层 埋孔 盲孔 内层线路 Substrates结构
www.chinafastprint.com Substrate加工工艺:HDI,Buiding up IC封装设计 介电层 绿油 铜层 埋孔 盲孔 通孔 金层 镍层 内层线路 Substrate结构
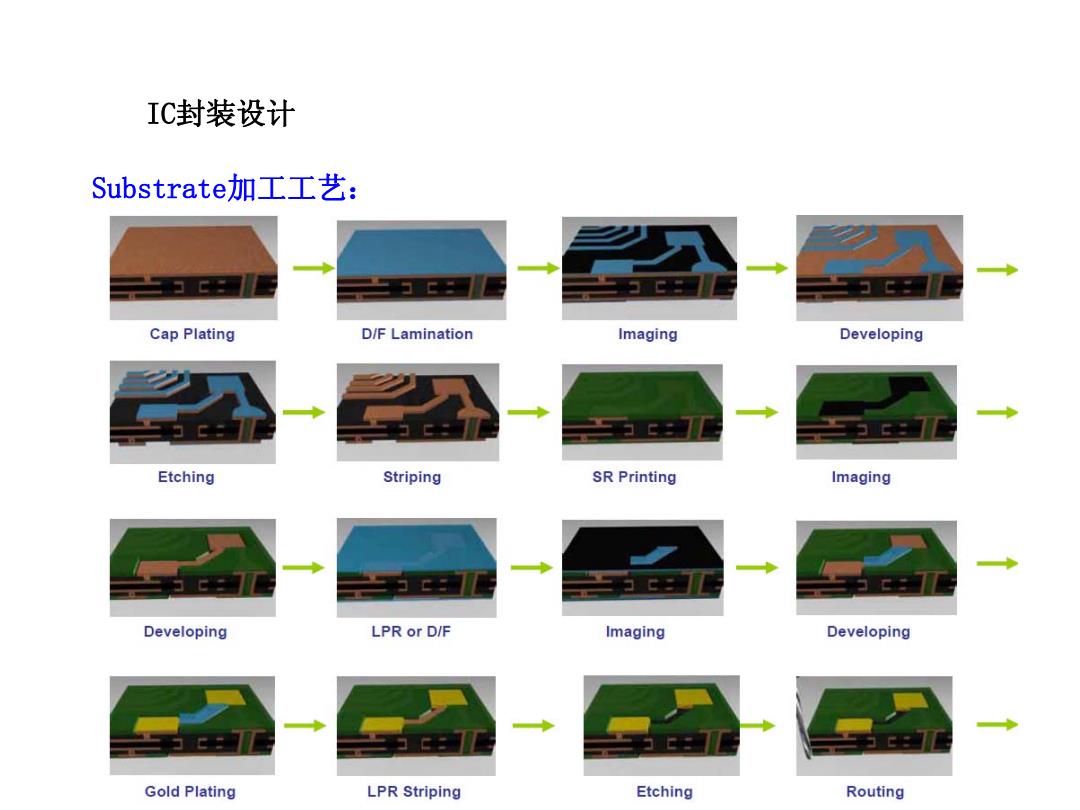
IC封装设计 Substrate加工工艺: -. Cap Plating D/F Lamination Imaging Developing 3C: Etching Striping SR Printing Imaging Developing LPR or D/F Imaging Developing Gold Plating LPR Striping Etching Routing
www.chinafastprint.com Substrate加工工艺: IC封装设计

IC封装设计 ITEM UNIT HTCC HTCC LTCC LTCC LTCC LTCC LTCC A440 Ao600 G940 G1771 GL950 GL330 GL331 Substrate: 板材 【HITCE】 1 Dielectric Constant 1MHz 9.8 9.0 53 7.8 2G收 88 187 52 9.4 77 7.6 10GHz 87 18.8 52 9.4 7.6 介电系数, Bectrical Dielectric Loss Angle 1MHz 10e-4 、 10 2G收 10e-4 24 21 的 36 5 12 正切损耗角, 10G 10e-4 15 33 38 14 Conductor Material 、 W/Mo Cu/W Cu Ag Cu Cu 导热系数, Sheet Resistance mQ/▣ 10-12 40 3.0 3.0 3.0 3.0 3.0 Thermal Expansion RT≈ 10e-6/K 7.1 72 10.7 12.3 8.5 8.2 72 热膨胀系数, 400℃1 Thermal Conductivity W/mK 14 15 35 2 4.1 43 32 Specific Heat 10e+3J/KgK 0.77 0.77 0.62 绿色材料, Q78 Flexural Strength MPa 400 400 220 170 400 400 400 价格因素。 Young's Moddes of Elasticity GPa 310 260 188 74 172 178 150 XY Shrinkage Tolerance ±1.0 ±1.0 ±1.0 ±1.0 ±0.25 ±1.0 ±1.0 Thun Layer Thickness um 50 25 名 0 5035) 20 Tg CTE Dk Df Tg CTE Dk Supplier Model deeC ppardeg.C RoHS? JPCA? Lead free? Supplier Model deec ppi deg.C RoHS? JPCA? Lead free☒ DMA TMA Z-5 1GH业 @IGHz DMA TMA 5 @1G业 @IGHz MGC HL832MG 205 50 41 0.0090 Yes No Yes R-5755(Megtron 5) 210 3.5 0.0040 Yes No Yes HL832EX 210 0 4.4 0.0090 Yes No Yes R-5715(Megtron) 180 702 3.7 0.0120 Yes No Yes HL832NB 205 41 0.0090 Yes Ye Yes Risbo PPE(CS-3376A) 195 702 33 0.0050 No No Yes HΠ832NX-A 230 30 4.7 0.0130 Yes Yes Yes Fokimx(GMPL195) 包C-4781 190 175 45 4.0 0.0220 No Getek ML200D 180 59 3.9 0.0120 Yes No Yes ELC-4785GS 265 220 16 4.2 0.0070 No Getek II 200 45 3.8 0.0050 日C.478 SGSLE -38 -0.006 PCL-HF-571 165 Yes Yes Yes Rogeis R03003 24 3.0 0.0013 PCL-LD-621 210 55 3.5 0.0050 Yes Yes Yes R03006 24 6.15 0.0020 R03010 24 102 0.0023 Hitachl MCL-E679 173 55 4.2 0.0195 Yes No Yes 25 48 R03203 58 MCL-E679FGB 165 0.0120 Yes Yes Yes 3.02 0.0016 MCL-Z R03206 45 6.15 0.0027 Yes Yes MCL-LX-67 185 0 3.4H 0.0043 R03210 34 10.2 0.0027 MCF-6000E 165 80-90 38 0.0260 Yes Yes R03035 24 33 0.0017 MCF-6000G 160 80-90 0.0250 Yes Yes R/fex LCP36003850 150 29 0.0020 Resin Coated Foi 115 100~11035 0.0250 Yes Yes MCH7IG 200 0.0060 Yes Yes PTFE 100 45 2.4 0.0010
www.chinafastprint.com Substrate:板材 IC封装设计 介电系数, 正切损耗角, 导热系数, 热膨胀系数, 绿色材料, 价格因素
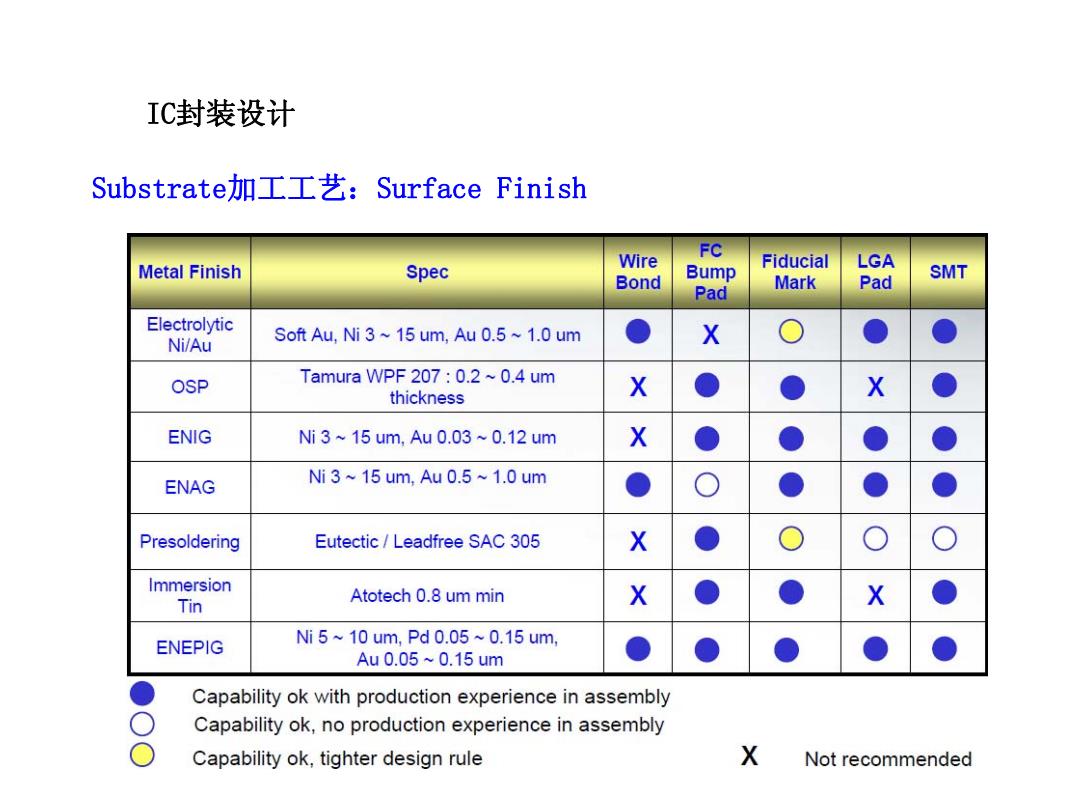
IC封装设计 Substrate加工工艺:Surface Finish FC Metal Finish Spec Wire Bond Bump Fiducial LGA Pad SMT Pad Mark Electrolytic Ni/Au Soft Au,Ni 3~15 um,Au 0.5~1.0 um X OSP Tamura WPF 207:0.2~0.4 um thickness X X ENIG Ni3~15um,Au0.03~0.12um X ENAG Ni 3~15 um,Au 0.5~1.0 um Presoldering Eutectic/Leadfree SAC 305 Immersion Tin Atotech 0.8 um min X X ENEPIG Ni5~10um,Pd0.05~0.15um, Au0.05~0.15um Capability ok with production experience in assembly Capability ok,no production experience in assembly Capability ok,tighter design rule X Not recommended
www.chinafastprint.com Substrate加工工艺:Surface Finish IC封装设计