
可擦除的PROM(EPROM) ①UVEPROM UVEPROM基本存储单元采用浮栅雪崩注入型 MOS管(简称FAMOS管),结构和符号如图所示。 D 若DS间加负高压(-45V,D与衬底间的PN结产生 雪崩击穿,耗尽区的电子从D的P+向外射出,速度快达 浮置栅,形成存储电荷。电压去掉后,能长期保存, 使D-S间形成导电沟道,FAMOS导通
可擦除的PROM(EPROM) ① UVEPROM UVEPROM基本存储单元采用浮栅雪崩注入型 MOS管(简称FAMOS管),结构和符号如图所示。 若DS间加负高压(-45V),D与衬底间的PN结产生 雪崩击穿,耗尽区的电子从D的P+向外射出,速度快达 浮置栅,形成存储电荷。电压去掉后,能长期保存, 使D-S间形成导电沟道,FAMOS导通

紫外线或X射线照射栅极氧化层,可使之放电。 FAMOS管截止,称擦除。为便于擦除,外壳有透明石 英盖板,如图所示。 石英盖板
紫外线或X射线照射栅极氧化层,可使之放电。 FAMOS管截止,称擦除。为便于擦除,外壳有透明石 英盖板,如图所示

用FAMOS管作基本存储单元时,还需一P沟道MOS管与之 串联,如图所示。 出厂时,FAMOS管都处于截止状态。 写:地址码使字线为低 VDD 电平;在需写“1的位线 上加负脉冲,相应的 FAMOS雪崩击穿。 字线 读:地址码使字线为低 T2 电平;已注入电荷的 FAMOS管导通,使位线变 FAMOS 位 Ti 为高电平,读出“1”;否 则,读出“0
用FAMOS管作基本存储单元时,还需一P沟道MOS管与之 串联,如图所示。 出厂时,FAMOS管都处于截止状态。 写:地址码使字线为低 电平;在需写“1”的位线 上加负脉冲,相应的 FAMOS雪崩击穿。 读:地址码使字线为低 电平;已注入电荷的 FAMOS管导通,使位线变 为高电平,读出“1”;否 则,读出“0
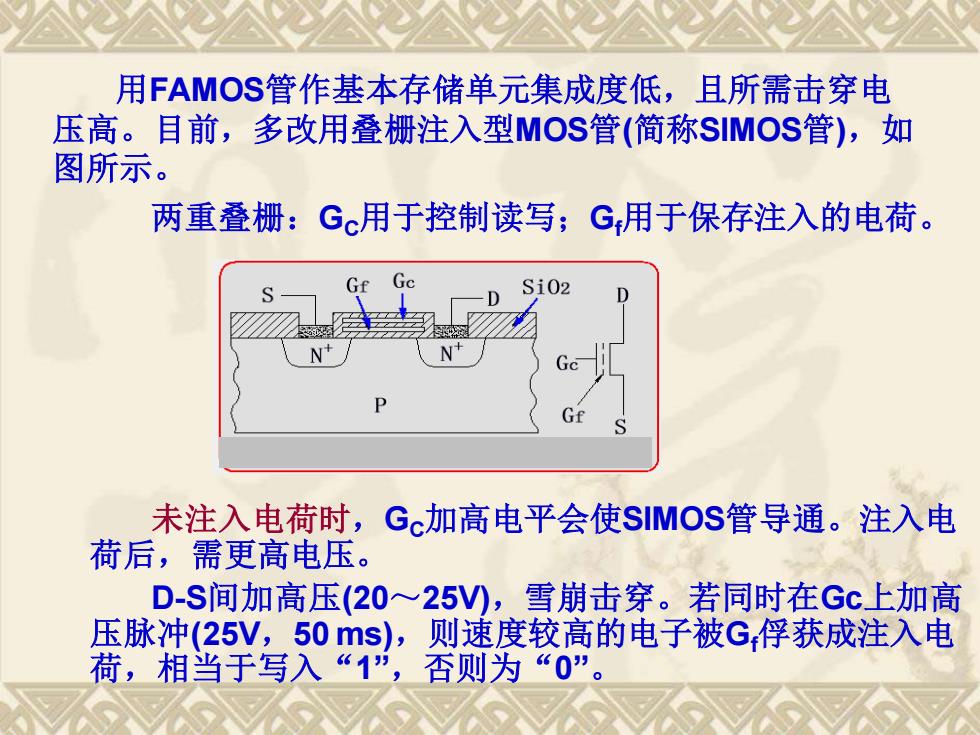
用FAMOS管作基本存储单元集成度低,且所需击穿电 压高。目前,多改用叠栅注入型MOS管(简称SIMOS管),如 图所示。 两重叠栅:Gc用于控制读写;G用于保存注入的电荷。 G Si02 D P 未注入电荷时,Gc加高电平会使SIMOS管导通。注入电 荷后,需更高电压。 D-S间加高压(20~25V),雪崩击穿。若同时在Gc上加高 压脉冲(25V,50ms),则速度较高的电子被G俘获成注入电 荷,相当于写入“1,否则为“0
用FAMOS管作基本存储单元集成度低,且所需击穿电 压高。目前,多改用叠栅注入型MOS管(简称SIMOS管),如 图所示。 两重叠栅:GC用于控制读写;Gf用于保存注入的电荷。 未注入电荷时,GC加高电平会使SIMOS管导通。注入电 荷后,需更高电压。 D-S间加高压(20~25V),雪崩击穿。若同时在Gc上加高 压脉冲(25V,50 ms),则速度较高的电子被Gf俘获成注入电 荷,相当于写入“1”,否则为“0