
中国科学技术大学物理系微电子考业 对实际晶体管,基区宽度W♪远小于少子扩散长度 Lp,对上式中的双曲函数取一级近似: PB(x)≈PBoe 房p01立 此时,基区少子分布可以近似为线性分布。 Principle of Semiconductor Devices 2023/5/2 26
中国科学技术大学物理系微电子专业 2023/5/2 Tuesday 26 • 对实际晶体管,基区宽度WB远小于少子扩散长度 LpB,对上式中的双曲函数取一级近似: ( ) (1 ) (0)(1 ) 0 W x p W x p x p e B B k T qV B B EB 此时,基区少子分布可以近似为线性分布。 Principle of Semiconductor Devices

中国科学技术大学物理系微电子专业 放大状态下的载流子分布示意图 EB EBJ WBase CBJ Principle of Semiconductor Devices 2023/5/2 27
中国科学技术大学物理系微电子专业 2023/5/2 Tuesday 27 放大状态下的载流子分布示意图 Principle of Semiconductor Devices
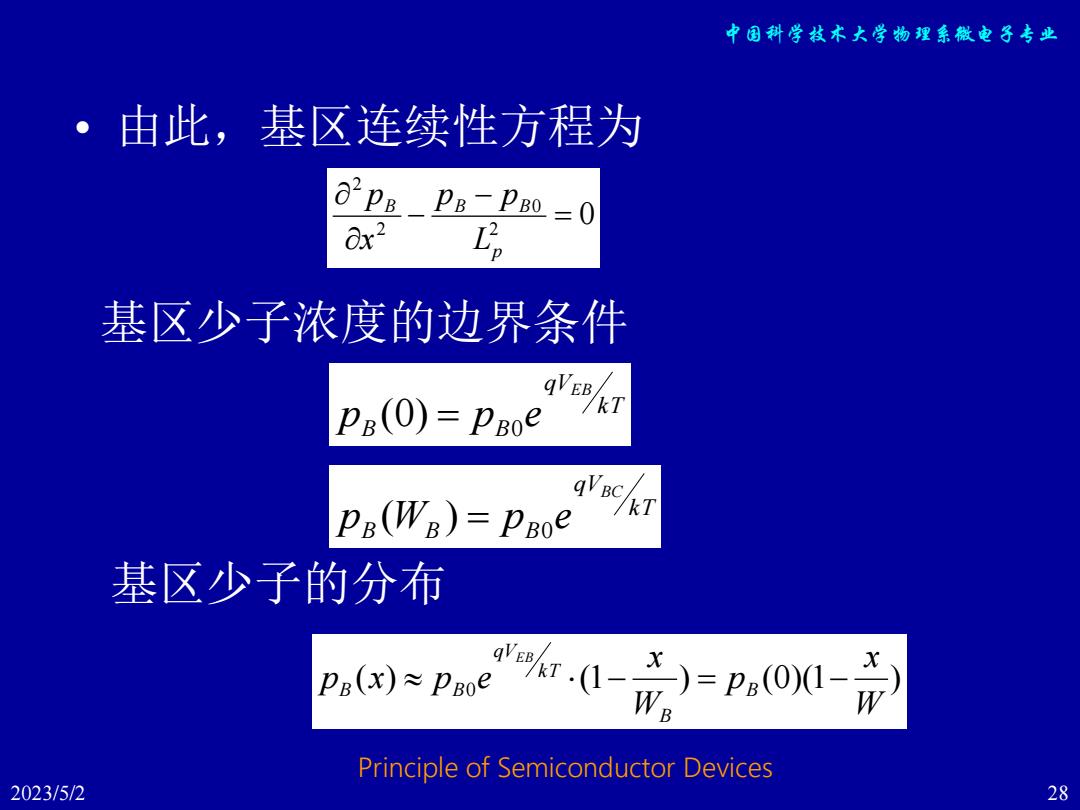
中国科学技术大学物理系微电子考业 ·由此,基区连续性方程为 8paPa-Pao=0 0x2 L, 基区少子浓度的边界条件 Pg(O)=PBoe Pe(WB)=PBoe aV aC/T 基区少子的分布 P.(=Pme%-0-)=p.00- Principle of Semiconductor Devices 2023/5/2 28
中国科学技术大学物理系微电子专业 2023/5/2 Tuesday 28 • 由此,基区连续性方程为 基区少子浓度的边界条件 k T qV B B B BC p W p e0 ( ) 基区少子的分布 0 2 0 2 2 p B B B L p p x p ( ) (1 ) (0)(1 ) 0 W x p W x p x p e B B k T qV B B EB k T qV B B EB p p e0 (0) Principle of Semiconductor Devices
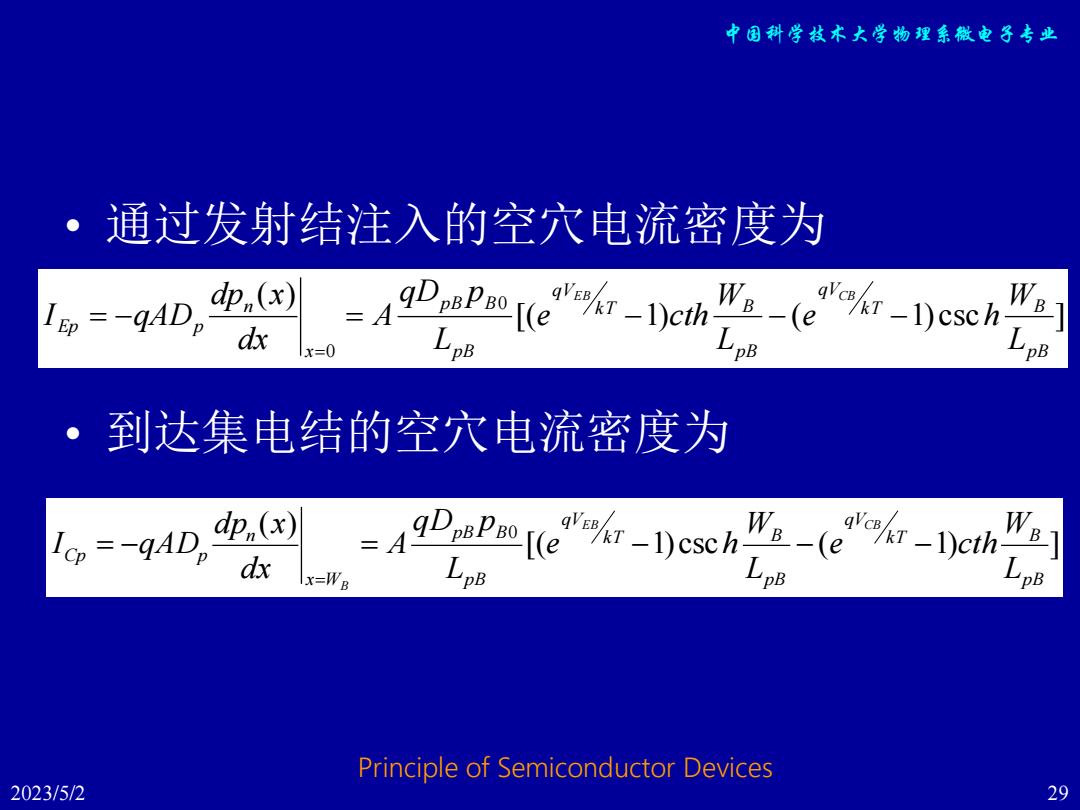
中国科学技术大学物理系微电子考业 通过发射结注入的空穴电流密度为 IEp=-qADp dp,(x) dx 2Pme"%-1ch =A x=0 到达集电结的空穴电流密度为 I=-9AD。 dp,(x) dx =Pe"%r-csch-eh-ch x-WB LpB LpB Principle of Semiconductor Devices 2023/5/2 29
中国科学技术大学物理系微电子专业 2023/5/2 Tuesday 29 • 通过发射结注入的空穴电流密度为 • 到达集电结的空穴电流密度为 [( 1) ( 1) csc ] ( ) 0 0 p B k T B q V p B k T B q V p B p B B x n Ep p L W e h L W e cth L qD p A dx dp x I qAD E B CB [( 1)csc ( 1) ] ( ) 0 pB k T B qV pB k T B qV pB pB B x W n Cp p L W e cth L W e h L q D p A d x d p x I qAD E B CB B Principle of Semiconductor Devices
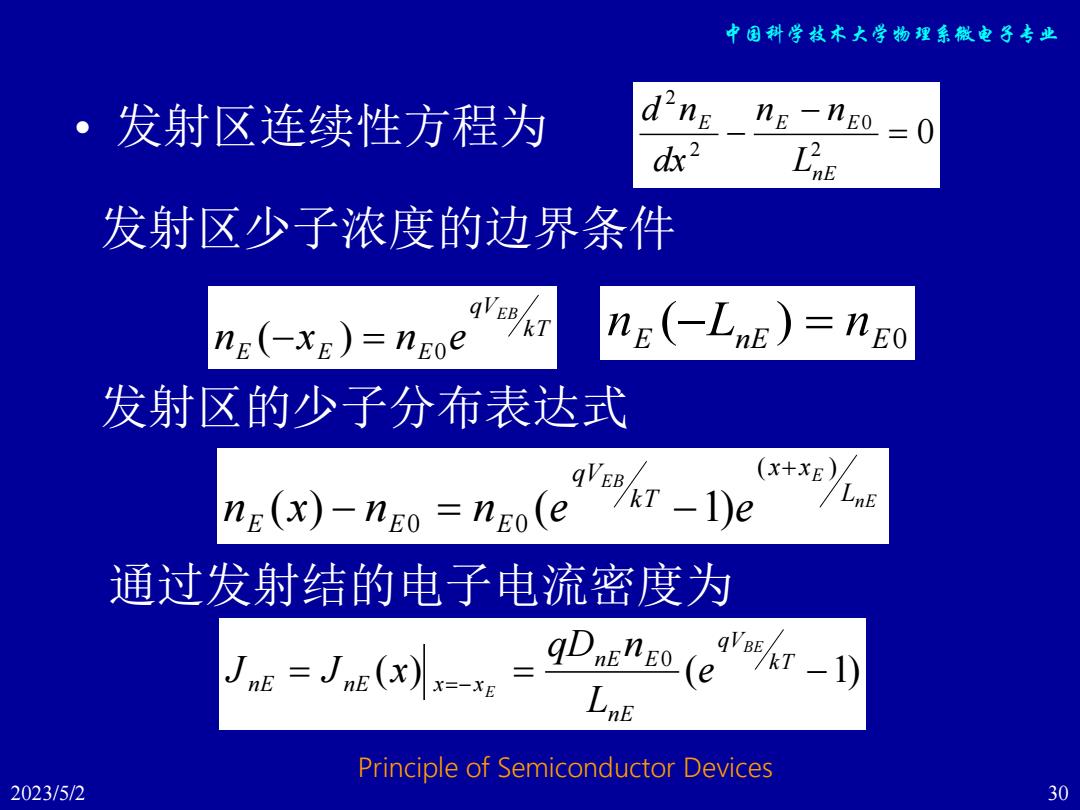
中国科学枝术大学物理系微电子专业 发射区连续性方程为 d'nE ng-nEo=0 dx2 L 发射区少子浓度的边界条件 nE(-XE)=nEoe V EB/kT nE(-LnE)=nEo 发射区的少子分布表达式 (x+XE ng(x)-nEo =ngo(e LnE 通过发射结的电子电流密度为 qDEnEo (e QVBE KT一1 LnE Principle of Semiconductor Devices 2023/5/2 30
中国科学技术大学物理系微电子专业 2023/5/2 Tuesday 30 • 发射区连续性方程为 0 2 0 2 2 nE E E E L n n dx d n 发射区少子浓度的边界条件 k T qV E E E EB n x n e0 ( ) 0 ( ) nE LnE nE n E E EB L x x k T qV E E E n x n n e e ( ) 0 0 ( ) ( 1) 发射区的少子分布表达式 通过发射结的电子电流密度为 ( ) ( 1) 0 k T qV nE nE E nE nE x x BE E e L qD n J J x Principle of Semiconductor Devices